DI Erich Thallner Strasse 1
4782 St. Florian am Inn
Austria
EV GROUP、ダイ・トゥ・ウェーハ(D2W) ハイブリッド接合向け活性化ソリューションを発表 3Dヘテロ集積化の開発を加速
EVG®320 D2W – 全自動接合界面活性化 / ダイ・トゥ・ウェーハ高精度配置装置は、サードパーティーの ダイボンダーとのシームレスな統合を可能にし、3Dヘテロ集積化向けハイブリッド接合を一気通貫で 実現するEVG装置ラインアップを完結
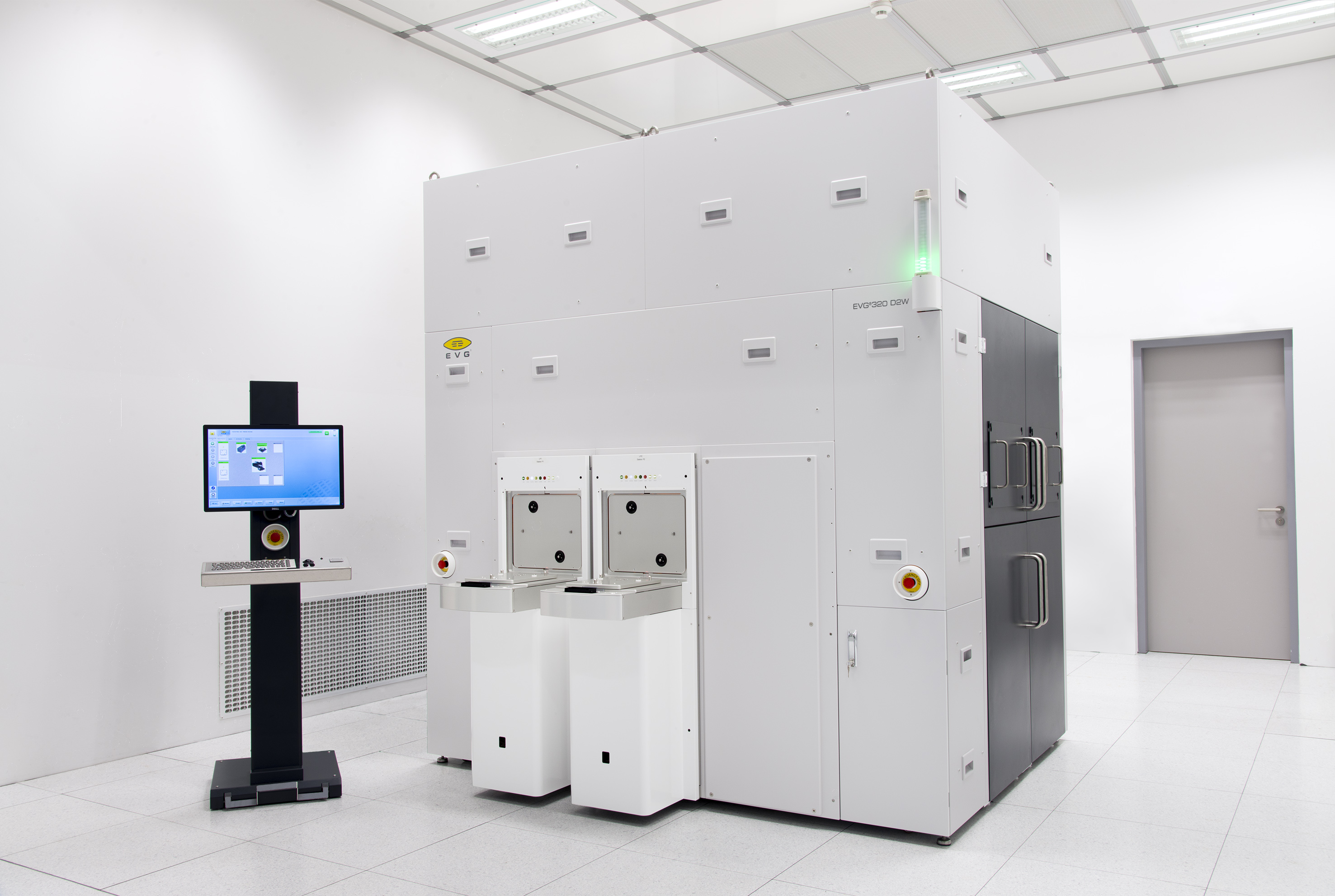
EVG®320 D2W - 全自動接合界面活性化 / ダイ・トゥ・ウェーハ高精度配置装置
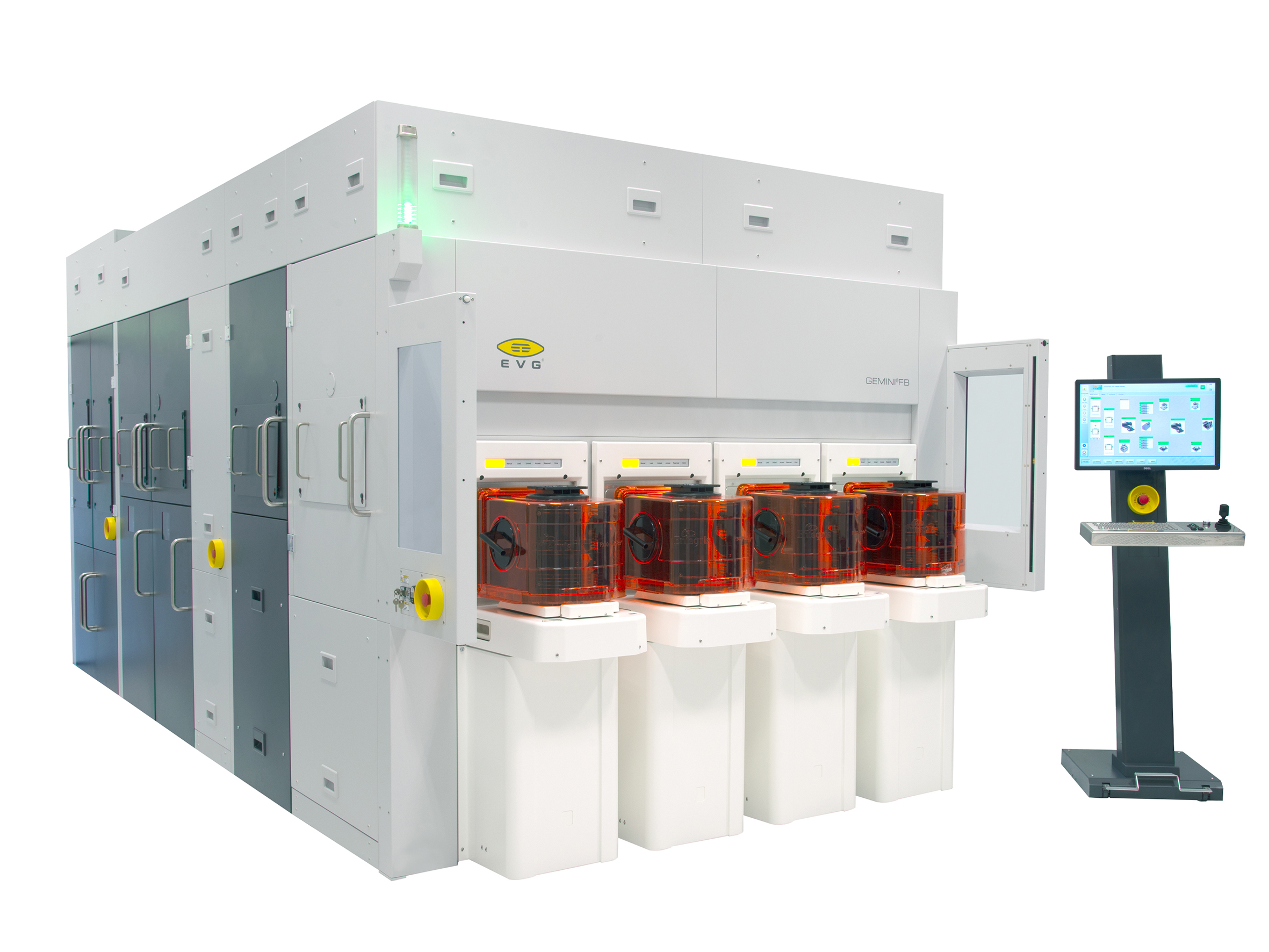
GEMINI®FB 統合型フュージョン接合装置
MEMS、ナノテクノロジーデバイス、半導体製造向けウェーハ接合およびリソグラフィ装置のリーディングサプライヤーであるEV Group(本社: オーストリア ザンクト・フローリアン、以下: EVG)は、業界初の商用ダイ・トゥ・ウェーハ(D2W)接合向けハイブリッド接合用活性化及び洗浄装置であるEVG®320 D2W を発表しました。この装置は、洗浄、プラズマ活性化、ダイアライメントの検証やその他の重要な計測機能を含むD2W接合に必要とされる全ての重要な前処理モジュールを装備し、単一のシステムとしても、またサードパーティーのピック・アンド・プレース式ダイボンダーを組み込んで使用することもできます。ハイブリッド接合技術におけるEVGの数十年にわたる経験を活かして開発されたEVG®320 D2W は、ヘテロ集積化の普及を加速化し、高帯域幅メモリ(HBM)、ロジック・オン・メモリ、チップレット、セグメント化された3Dシステム・オン・チップ(SoC)デバイス、3D積層裏面照射型CMOSイメージセンサー等の新世代デバイスやシステムの製造を可能にします。
ハイブリッド接合はヘテロ集積化を実現するプロセス
人工知能(AI)、自動運転、拡張/仮想現実(AR/VR)、そして5G等といった先端アプリケーションでは、生産コストを増大させることなく、高帯域幅に対応した高性能かつ低消費電力デバイスを開発することが求められています。従来の2Dシリコンスケーリングが製造コストの問題に直面し、半導体産業はヘテロ集積化による製造へと移行しつつあり、1つのデバイスもしくはパッケージ内に、さまざまなサイズ・材質による異なる部品やダイを複数集積することで、次世代デバイスの性能向上を図ろうとしています。
異なる生産ラインで製造されたウェーハを積層して電気的に接続するウェーハ・トゥ・ウェーハ(W2W)ハイブリッド接合は、ヘテロ集積化における中心的なプロセスであり、CMOSイメージセンサーや各種メモリとロジックの統合等、特定のアプリケーションで既に実証されています。しかし、ダイが同じサイズでない場合では、D2Wによるハイブリッド接合が、ヘテロ集積化を可能にする有効な手段となります。この新しいD2W 接合と、市場をリードするW2Wハイブリッド接合から導かれる卓越した経験、及びヘテロジニアス・インテグレーション・コンピテンスセンター™が 支援する業界内のコラボレーションによって、EVG は各種D2W 接合アプリケーションをサポートするための最高の体制を整えています。
EV Groupでエグゼクティブ・テクノロジー・ディレクターを務めるPaul Lindnerは、次のように述べています。「EVGはウェーハ接合ソリューションにおいて世界最大の納入実績を備え、ウェーハ・トゥ・ウェーハでのハイブリッドおよびフュージョン接合において20年間にわたり、新たな基準を継続的に構築してきました。新興のダイ・トゥ・ウェーハ接合に対しては、既存のEVG GEMINI® FBシステムをベースに専用仕様を用意することで、市場の要求に対応を始めています。新規のEVG320 D2W全自動接合界面活性化 / ダイ・トゥ・ウェーハ高精度配置装置では、ダイ・トゥ・ウェーハ接合で培われたノウハウを付加し、ハイブリッド接合ソリューションを一気通貫で提供可能なEVGの装置ポートフォリオを完全構築することで、3D / ヘテロ集積化の展開を加速いたします。将来的には、ヘテロ集積化アプリケーション向けにウェーハ・トゥ・ウェーハとダイ・トゥ・ウェーハ両方のプロセスフローが必要になり、多くの生産工場で並行してそれらが行われるようになると予想されます。この重要かつ急成長が見込まれる技術分野に対し、EVGはより幅広くソリューションを提供できると考えています。」
ダイ・トゥ・ウェーハ・プロセスフロー
アプリケーションや顧客からの要件に応じて、異なるD2W接合方式が選択・利用可能です。一括式D2W(Co-D2W)接合では、個片化したダイをキャリア上に仮配置し、GEMINI FB 等のW2Wハイブリッド・フュージョン接合装置を使用して、ダイをターゲットウェーハ上に一括移送し接合を行います。一方、直接配置式D2W(DP-D2W)接合では、フリップチップボンダーを使用して、個片化したダイをターゲットウェーハ上にピック&プレース方式で1つずつ接合します。搬送用ウェーハ上に配置したダイ表面へプラズマ活性化と洗浄を行うことは、ダイを高歩留りで接合し、ターゲットウェーハとの間で良好な電気的接続を得るために欠かせないステップです。この工程でEVG320 D2W活性化システムが用いられます。
製品の詳細
EVG320 D2Wは、サードパーティーのピック&プレース・ダイ・ボンディング・システムとシームレスに統合可能な、ハードウェア / ソフトウェアインターフェイスを備えた非常に柔軟なプラットフォームです。また、プロセス統合およびラインバランシングの要件に応じて、単体装置として運用することもできます。このシステムには、EVGの先進的な洗浄およびプラズマ活性化技術が組み込まれています。これは、業界標準である同社のW2Wフュージョンおよびハイブリッド接合プラットフォームの応用であり、世界中で数百台の導入実績を誇るプロセスモジュールで実証済です。さらに、EVG320 D2Wは、EVGのアライメント検証モジュール(AVM)を備えています。これは、ダイの配置精度やダイの高さ情報など重要なプロセスパラメータをダイボンダーに直接フィードバックし、全体のプロセスフローを最適化する為の統合型計測モジュールです。追加機能として、プラズマ活性化ハイブリッド / フュージョン接合に必要な清浄度基準を満たし、あらゆるタイプのダイキャリアまたはフィルムフレームに対応できる柔軟な基板搬送、およびSECS / GEM標準のサポートが含まれます。
製品の購入について
EVGは、新EVG320 D2Wダイ・プリパレーション/活性化システムの受注を開始しています。また、オーストリア本社にあるEVGのヘテロジニアス・インテグレーション・コンピテンスセンターでは、製品のデモンストレーションが可能です。詳細については、https://www.evgroup.com/ja/products/bonding/die-to-wafer-bonding-systems/evg320d2w/をご覧ください
EV GROUP(EVG)について
EV Group(EVG)は半導体、MEMS、化合物半導体、パワーデバイスおよびナノテクノロジーデバイスの製造装置およびプロセスソリューションのリーディングサプライヤーです。主要製品には、ウェーハ接合、薄ウェーハプロセス、リソグラフィ/ナノインプリント・リソグラフィ(NIL)や計測機器だけでなく、フォトレジストコーター、クリーナー、検査装置などがあります。1980年に設立されたEVGは、グローバルなお客様および世界中のパートナーに対し緻密なネットワークでサービスとサポートを提供します。 EVGに関する詳しい情報はwww.EVGroup.comをご参照ください。
お問い合わせ先
イーヴィグループジャパン株式会社 マーケティング担当
TEL: 045-348-0665
E-mail: Marketing+CommunicationsJapan@EVGroup.com
Clemens Schütte
Director, Marketing and Communications
EV Group
Tel: +43 7712 5311 0
E-mail: Marketing@EVGroup.com
David Moreno
Principal
Open Sky Communications
Tel: +1.415.519.3915
E-mail: dmoreno@openskypr.com
ミアキス・アソシエイツ 河西
E-mail: kasai@miacis.com