DI Erich Thallner Strasse 1
4782 St. Florian am Inn
Austria
- Produkte
-
Technologien
- IR LayerRelease™ Technology
- MLE™ - Maskless Exposure Technologie
- Nanopräge-Lithographie (NIL) - SmartNIL®
- Wafer-Level Optics
- Optische Lithographie
- Fotolackverarbeitung
- Temporäres Bonden und De-Bonden
- Eutektisches Bonden
- Transient Liquid Phase (TLP) Bonden
- Anodisches Bonden
- Metall-Diffusionsbonden
- Hybrid- und Fusionsbonden
- Die-to-Wafer Fusion and Hybrid Bonding
- ComBond® Technologie
- Metrologie
- Unternehmen
- Karriere
EV Group enthüllt Hybrid Die-to-Wafer-Bonding Aktivierungslösung zur Beschleunigung der 3D- / Heterogenen Integration
EVG®320 D2W Die Preparation and Activation System erlaubt die nahtlose Integration mit Die-Bondern von Drittanbietern und vervollständigt das Produktportfolio von EVG für End-to-End-Hybrid-Bonding für 3D- / Heterogene Integration
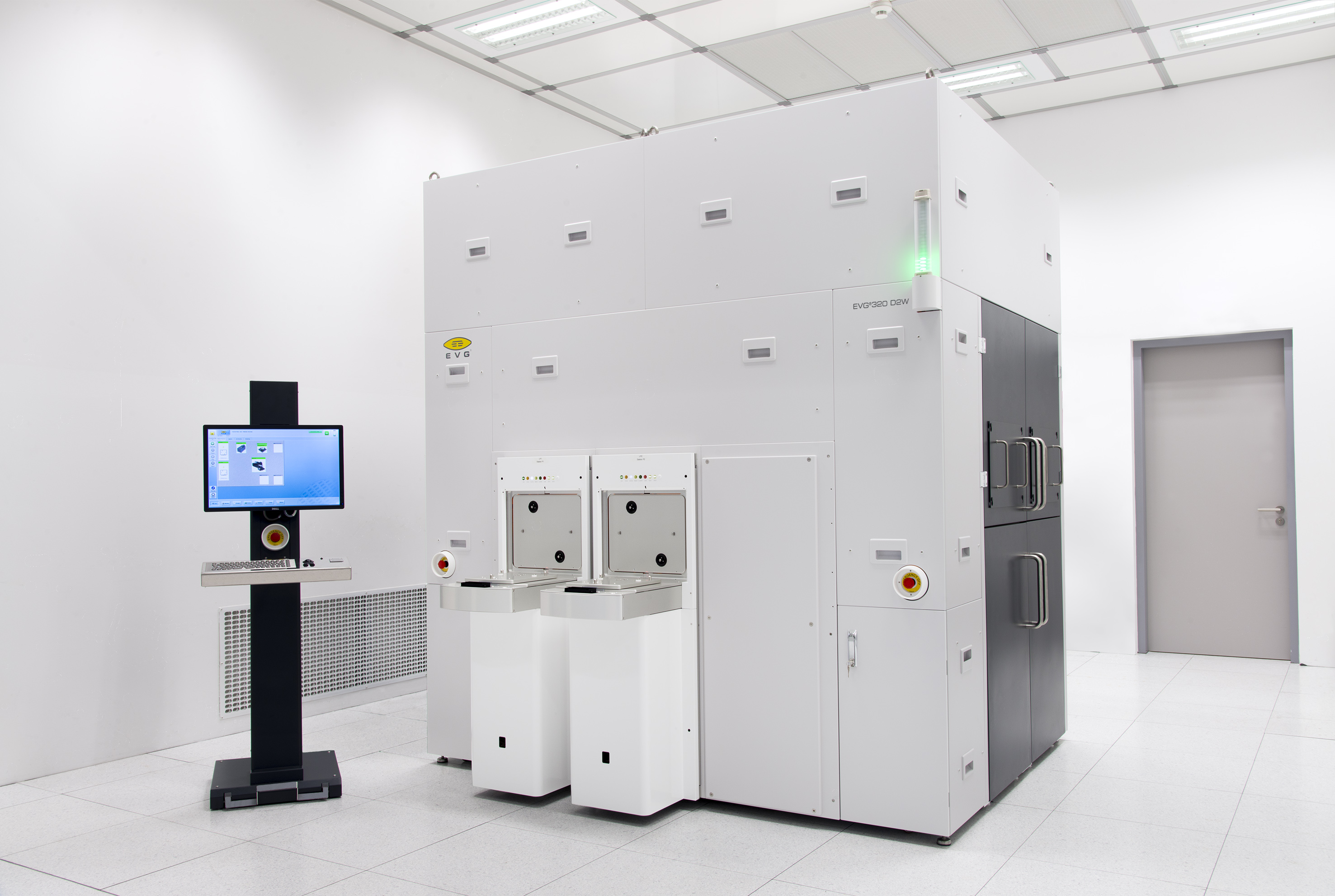
EVG®320 Die Preparation and Activation System
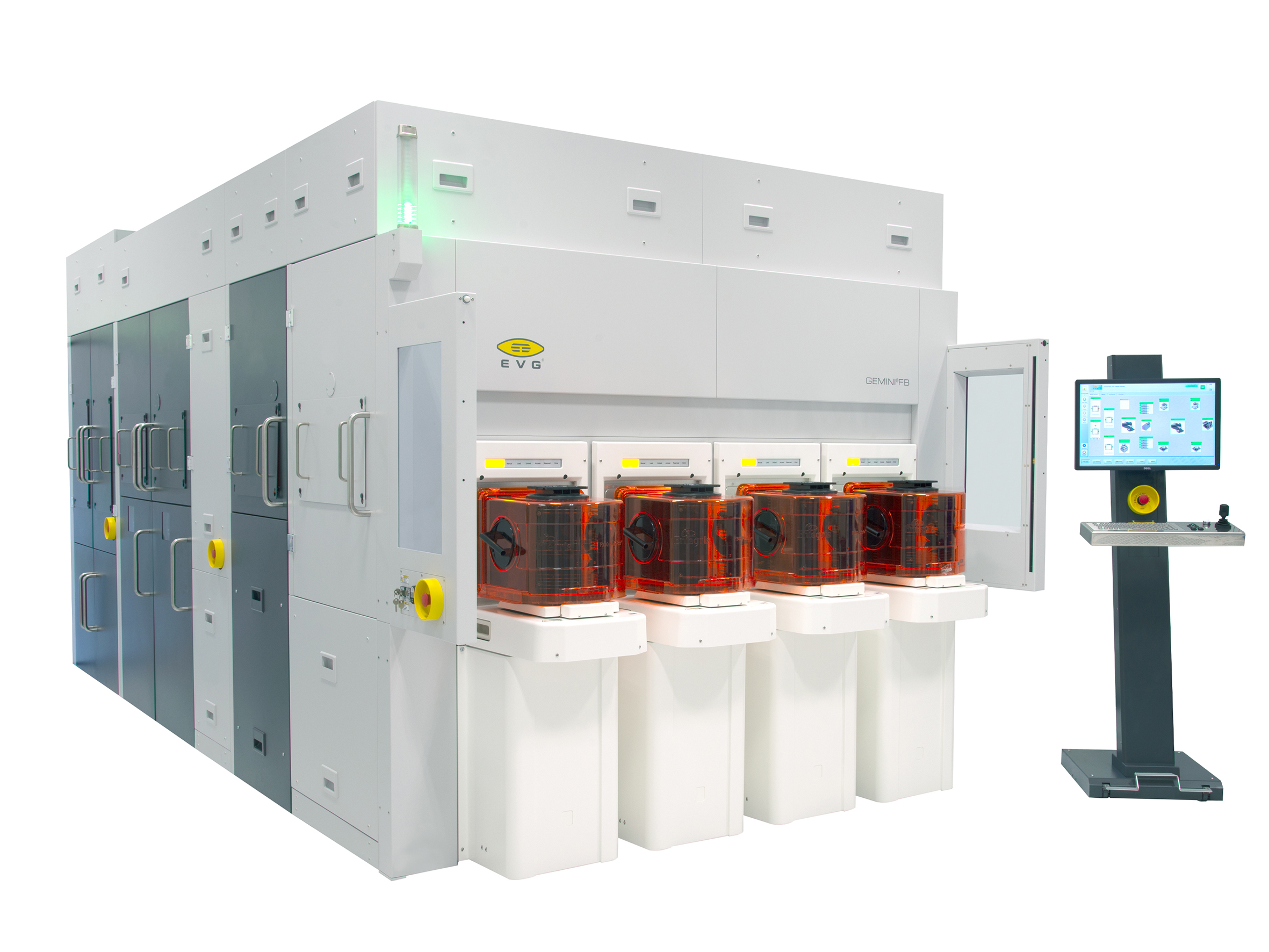
GEMINI®FB Integrated Fusion Bonding System
ST. FLORIAN, Österreich, 10. Dezember 2020 — EV Group (EVG), ein führender Entwickler und Hersteller von Anlagen für Waferbonding- und Lithographieanwendungen in der Halbleiterindustrie, Mikrosystemtechnik und Nanotechnologie, stellte heute das Die Preparation and Activation System namens EVG®320 D2W vor - das erste kommerziell verfügbare Aktivierungs- und Reinigungssystem für das hybride Die-to-Wafer (D2W)-Bonden. Das System, das sowohl eigenständig als auch integriert mit Pick-and-Place-Die-Bonding-Systemen von Drittanbietern betrieben werden kann, umfasst Prozessmodule für alle wichtigen, für das D2W-Bonden erforderlichen Vorbereitungsschritte einschließlich Reinigung, Plasma-Aktivierung sowie Messtechnik zur Überprüfung der Die-Ausrichtung und andere Metrologieverfahren. Unter Nutzung der jahrzehntelangen Erfahrung von EVG in der Hybrid-Bonding-Technologie erfüllt das EVG320 D2W System die kritische Nachfrage nach innovativen Prozesslösungen, die den Einsatz der heterogenen Integration beschleunigen können. Dadurch werden neue Generationen von Bauelementen und Systemen wie z.B. High-Bandwidth Memory (HBM), Logic-on-Memory, Chiplets, segmentierte und 3D-System-on-Chip (SoC)-Bauelemente und 3-dimensional gestapelte, rückseitig belichtete CMOS-Bildsensoren ermöglicht.
Hybrid-Bonden ermöglicht die heterogene Integration
Zukunftsweisende Anwendungen wie künstliche Intelligenz (KI), autonomes Fahren, Augmented / Virtual Reality (AR/VR) und 5G erfordern die Entwicklung von Devices mit hoher Bandbreite, hoher Leistung und geringem Stromverbrauch, ohne die Produktionskosten zu erhöhen. Da die traditionelle 2D-Skalierung auf Silizium-Basis an ihre Kostengrenzen stößt, wendet sich die Halbleiterindustrie der heterogenen Integration zu: der Herstellung, Montage und Verpackung mehrerer, unterschiedlicher Komponenten oder Dies bzw. Chips mit unterschiedlichen Strukturgrößen und Materialien auf einem einzigen Device oder Package, um die Leistung neuer Gerätegenerationen zu steigern.
Das Wafer-to-Wafer (W2W)-Hybridbonden, bei dem Wafer aus verschiedenen Produktionslinien gestapelt und elektrisch verbunden werden, ist ein zentraler Prozess bei der heterogenen Integration und hat sich für bestimmte Anwendungen wie CMOS-Bildsensoren und verschiedene Speicher- und Logiktechnologien bewährt. In Fällen, in denen die Komponenten oder Dies bzw. Chips nicht die gleiche Größe haben, bietet jedoch auch das D2W-Hybridbonden einen gangbaren Weg, um eine heterogene Integration zu ermöglichen. Mit seinem neuen Angebot zum D2W-Bonden, der umfangreichen Erfahrung mit seinen marktführenden W2W-Hybridbonding-Lösungen und vielen Industriekooperationen, die durch das Kompetenzzentrum für heterogene Integration (EVG Heterogeneous Integration Competence Center™) unterstützt werden, ist EVG optimal positioniert, um D2W-Bonding-Anwendungen zu unterstützen.
"Seit 20 Jahren setzt EVG mit der weltweit größten installierten Basis von Wafer-to-Wafer-Hybrid- und Fusionsbonding-Lösungen kontinuierlich neue Standards", sagte Paul Lindner, Executive Technology Director von EV Group. "Wir haben bereits damit begonnen, die Bedürfnisse des aufstrebenden Die-to-Wafer-Markts mit einer dedizierten Version unseres etablierten EVG GEMINI® FB-Systems zu bedienen, die speziell für das Die-to-Wafer-Bonden konfiguriert ist. Das neue EVG320 D2W Die Preparation and Activation System ergänzt unsere Kompetenzen im Bereich Die-to-Wafer-Bonden und vervollständigt unser Produktportfolio, um so eine durchgängige Hybrid-Bonding-Lösung anbieten und den Einsatz der 3D- bzw. heterogenen Integration beschleunigen zu können. Wir gehen davon aus, dass in Zukunft sowohl Wafer-zu-Wafer- als auch Die-zu-Wafer-Prozessabläufe erforderlich sein und in zahlreichen Fabs für heterogene Integrationsanwendungen parallel ablaufen werden – wodurch sich für EVG viele Möglichkeiten bieten, diese kritische und schnell wachsende Technologielandschaft zu unterstützen".
Die-to-Wafer-Prozessablauf
Je nach Anwendung und spezifischen Kundenanforderungen stehen mehrere, unterschiedliche D2W-Bonding-Methoden zur Verfügung und Auswahl. Beim kollektiven D2W-Bonden (Co-D2W) werden vereinzelte Dies bzw. Chips auf kollektive Träger platziert und mit einem W2W-Hybrid- oder Fusionsbonding-System, wie dem GEMINI FB, gleichzeitig auf den Ziel-Wafer gebondet. Beim Direct Placement D2W-Bonden (DP-D2W) werden die vereinzelten Dies nacheinander mit Hilfe eines Pick-and-Place-Flip-Chip-Bonders auf den Ziel-Wafer gebondet. Die Plasma-Aktivierung und Reinigung der Oberflächen der Chips auf dem Carrier-Wafer sind wesentliche Schritte zur Herstellung einer zuverlässigen, mechanischen und elektrischen Verbindung zwischen den Dies und dem Ziel-Wafer bei hoher Produktionsausbeute. Genau hier kommt das EVG320 D2W-Aktivierungssystem zum Einsatz.
Produkt-Details
Das EVG320 D2W System ist eine hochflexible Plattform mit einer universellen Hardware- und Software-Schnittstelle, die eine nahtlose Integration mit Pick-and-Place-Die-Bonding-Systemen von Drittanbietern ermöglicht. Je nach Integrationsanforderungen und zum Abgleich des Durchsatzes ist auch der Betrieb als eigenständiges System möglich. Das System verfügt über die fortschrittliche Reinigungs- und Plasma-Aktivierungstechnologie von EVG, die in den industrieweit als Standard etablierten W2W-Fusions- und Hybrid-Bonding-Plattformen zum Einsatz kommt und sich in Hunderten von weltweit installierten Modulen bewährt hat. Darüber hinaus verfügt das EVG320 D2W über das Alignment-Verifikationsmodul (AVM) von EVG, das als integriertes Metrologiemodul sowohl direktes Feedback zu kritischen Prozessparametern, wie z.B. zur Die-Platzierungsgenauigkeit und Höhe der einzelnen Dies, an den Die-Bonder liefern als auch als Post-Bond-Metrologiesystem für eine verbesserte Prozesskontrolle sorgen kann. Das System zeichnet sich zudem durch eine flexible Substrathandhabung aus, die jede Art von Die-Träger oder Film Frame für die Plasmaaktivierung aufnehmen kann, es erfüllt die hohen Reinheitsanforderungen für Hybrid- und Fusionsbonding-Anwendungen und unterstützt SECS/GEM-Standards.
Produkt-Verfügbarkeit
EVG nimmt ab sofort Bestellungen für das neue EVG320 D2W Die Preparation and Activation System entgegen und bietet Produktdemonstrationen im Rahmen der Heterogeneous Integration Competence Centers™ am Hauptsitz in Österreich an. Weitere Informationen finden Sie unter https://www.evgroup.com/de/products/bonding/die-to-wafer-bonding-systems/evg320d2w/.
Über EV Group (EVG):
Die EV Group (EVG) ist anerkannter Technologie- und Marktführer für Präzisionsanlagen und Prozesslösungen zur Waferbearbeitung in der Halbleiterindustrie, Mikrosystemtechnik und Nanotechnologie. Zu den Kernprodukten gehören Waferbonder, Systeme zur Dünnwafer-Bearbeitung, Lithographie- und Nanoprägelithographie-Systeme sowie Fotoresist-Belacker, Reinigungs- und Metrologiesysteme. Das 1980 gegründete Unternehmen mit Hauptsitz in St. Florian am Inn (Austria) beschäftigt mehr als 1000 Mitarbeiter und betreut mit eigenen Niederlassungen in USA, Japan, Korea, China und Taiwan sowie Repräsentanzen namhafte Produktionskunden und R&D-Partner in aller Welt. Für mehr Informationen siehe www.EVGroup.com.
Kontakte:
Clemens Schütte
Director, Marketing and Communications
EV Group
Tel: +43 7712 5311 0
E-mail: Marketing@EVGroup.com
David Moreno
Principal
Open Sky Communications
Tel: +1.415.519.3915
E-mail: dmoreno@openskypr.com