DI Erich Thallner Strasse 1
4782 St. Florian am Inn
Austria
- Produkte
-
Technologien
- IR LayerRelease™ Technology
- MLE™ - Maskless Exposure Technologie
- Nanopräge-Lithographie (NIL) - SmartNIL®
- Wafer-Level Optics
- Optische Lithographie
- Fotolackverarbeitung
- Temporäres Bonden und De-Bonden
- Eutektisches Bonden
- Transient Liquid Phase (TLP) Bonden
- Anodisches Bonden
- Metall-Diffusionsbonden
- Hybrid- und Fusionsbonden
- Die-to-Wafer Fusion and Hybrid Bonding
- ComBond® Technologie
- Metrologie
- Unternehmen
- Karriere
EV Group erreicht mit 100 Prozent Ausbeute beim Die-Transfer von 3D Systems-on-a-Chip mit mehreren Dies einen wichtigen Meilenstein für das Fusions- und hybride Die-to-Wafer Bonding
Erfolgreicher Die-to-Wafer-Transfer kompletter Systeme im Heterogeneous Integration Competence Center™ von EVG demonstriert wichtigen Fortschritt in Richtung Prozessreife

Beispiel eines erfolgreich gebondeten 3D System-on-a-Chip (SoC) Devices.
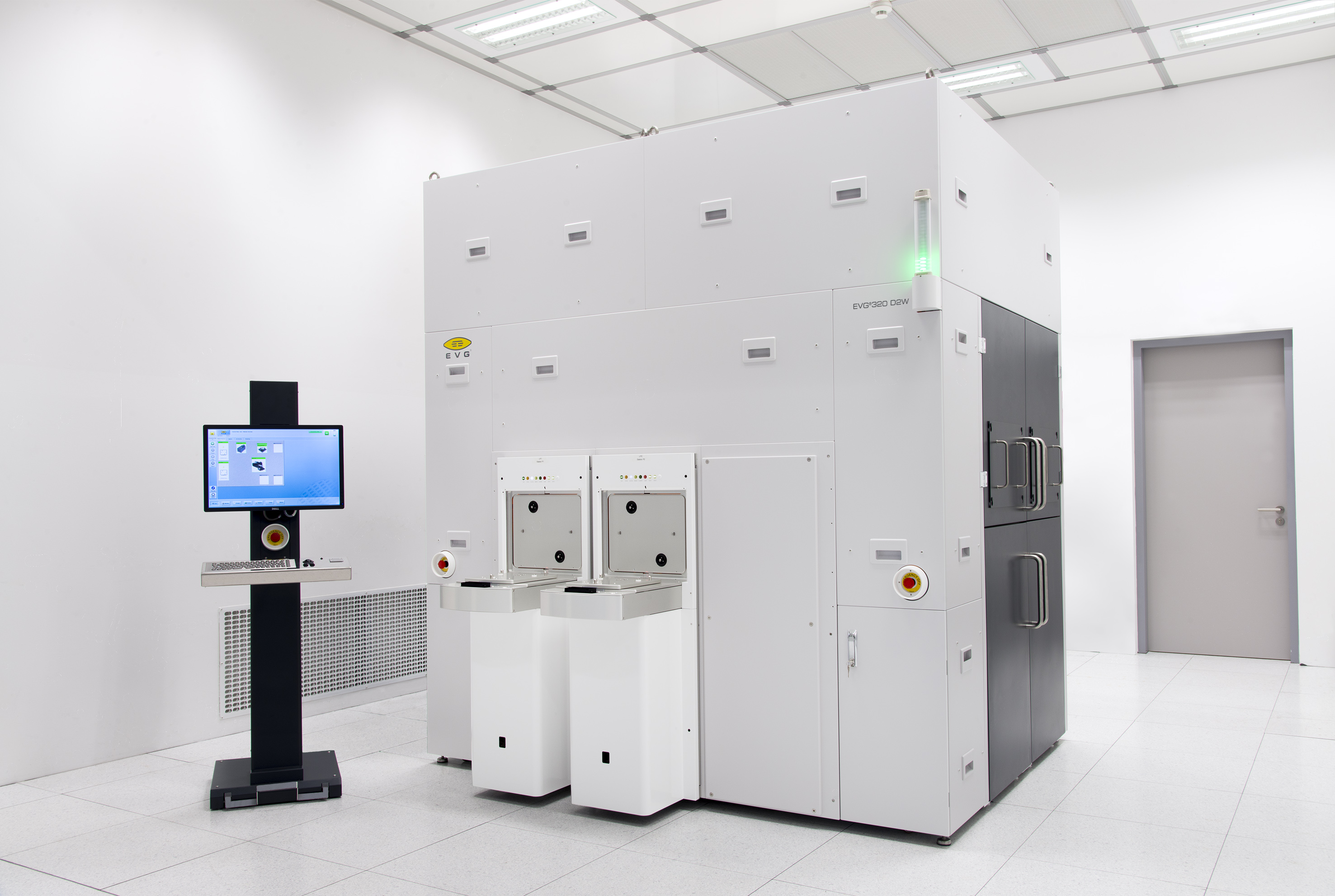
EVG®320 D2W Automated Die Preparation and Activation System
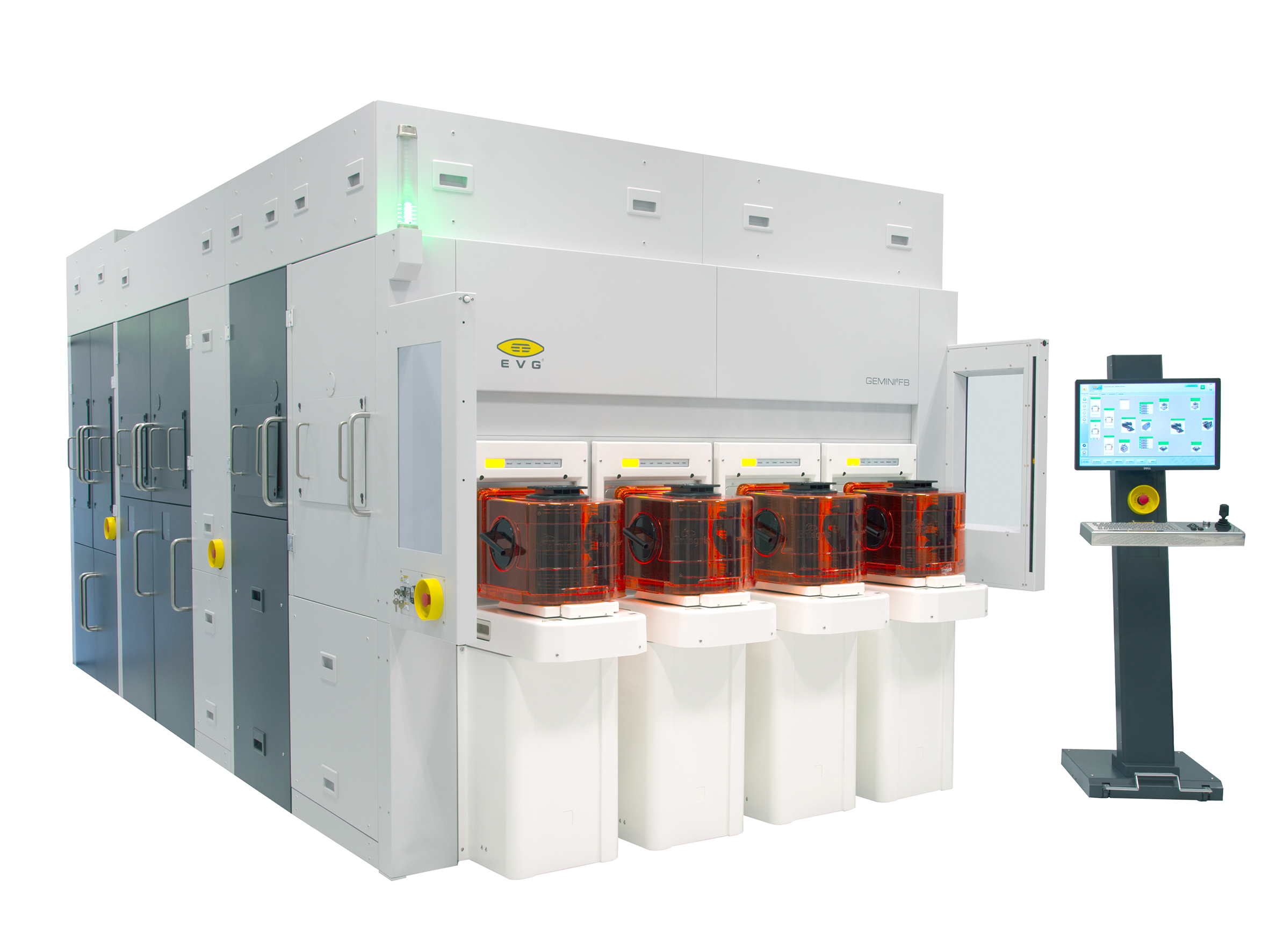
GEMINI® FB Automated Production Wafer Bonding System

EVG®40 NT2 Automated Measurement System
ST. FLORIAN, Österreich, 12. Juli 2022 — EV Group (EVG), ein führender Entwickler und Hersteller von Anlagen für Waferbonding- und Lithographieanwendungen in der Halbleiterindustrie, Mikrosystemtechnik und Nanotechnologie, gab heute bekannt, dass ein bedeutender Durchbruch beim Die-to-Wafer (D2W) Fusions- und Hybrid-Bonding erzielt wurde. Mit dem automatisierten Hybrid-Bonding-System GEMINI®FB von EVG konnte eine 100-prozentige, fehler- bzw. void-freie Ausbeute beim Bonden mehrerer Chips unterschiedlicher Größe eines kompletten 3D Systems-on-a-Chip (SoC) in einem einzigen Transferprozess nachgewiesen werden. Das Erreichen dieses Ergebnisses stellte bis heute eine zentrale Herausforderung für das D2W-Bonden und eine große Hürde bei der Senkung der Kosten für die Implementierung der heterogenen Integration dar. Diese industrieweit bedeutende Leistung wurde im Heterogeneous Integration Competence Center™ (HICC) von EVG erbracht, das darauf ausgelegt ist, Kunden bei der Nutzung der Prozesslösungen und des Fachwissens von EVG zu unterstützen und dadurch die Entwicklung neuer und differenzierender Produkte und Anwendungen zu beschleunigen, die durch Fortschritte in der Systemintegration und beim Packaging vorangetrieben werden.
Zukunftsweisende Anwendungen wie künstliche Intelligenz (KI), autonomes Fahren, Augmented/Virtual Reality und 5G erfordern die Entwicklung von Devices mit hoher Bandbreite und hoher Leistung bei geringem Stromverbrauch, ohne die Produktionskosten zu erhöhen. Daher setzt die Halbleiterindustrie auf die heterogene Integration – die Herstellung, Montage und Verpackung mehrerer verschiedener Komponenten oder Dies mit unterschiedlichen Strukturgrößen und Materialien auf einem einzigen Device oder Package – um die Leistung neuer Produktgenerationen zu steigern. Das D2W-Hybridbonden ist eine Schlüsseltechnologie für die heterogene Integration, da jedoch der immer höhere Bandbreitenbedarf dieser Produkte neuere Packaging-Technologien vorantreibt sind auch neue Entwicklungen beim D2W-Hybridbonden und im Bereich der Messtechnik erforderlich.
"Das Hybridbonden erfordert wesentlich andere Fertigungstechnologien als Standard-Packaging-Prozesse und rückt damit viel näher an die Front-End-Fertigung heran - insbesondere in Bezug auf Sauberkeit, Partikelkontrolle, Alignment und Messgenauigkeit", so Dr. Thomas Uhrmann, Business Development Director bei EV Group. "Im Einklang mit unserer Marktführerschaft beim W2W-Hybridbonden bauen wir unsere Lösungen für das D2W-Hybridbonden weiter aus und optimieren unsere Anlagen, um kritische vor- und nachgelagerte Prozesse, wie z.B. die Plasma-Aktivierung und Reinigung, zu unterstützen und so die Einführung und den Reifegrad des D2W-Hybridbondens zu beschleunigen. Mit unserem etablierten GEMINI FB System, das für kollektive D2W-Integrationsflüsse konfiguriert wurde und bereits seit mehreren Jahren die Anforderungen für das D2W-Bonden erfüllt, dem EVG®320 D2W Die-Preparation and Activation System für D2W Direct Placement Bonding-Anwendungen mit einer direkten Schnittstelle zu D2W-Bondern und dem EVG®40 NT2 Overlay-Metrologiesystem, das KI Feed-Forward- und Feedback-Schleifen zur weiteren Erhöhung der Ausbeute beim Hybridbonden nutzt, bietet EVG eine vollständige, durchgängige Hybrid Bonding-Lösung, um die Einführung der 3D- / heterogen Integration zu beschleunigen."
Da es sich beim Hybridbonden um eine „Solid-State“ Schnittstelle mit eingebetteten Metallpads handelt, die eine direkte, elektrische Face-to-Face-Verbindung von Wafern und Dies ermöglichen, erfordert das D2W-Hybridbonden ähnlich strenge Reinheitsstandards und Fertigungstoleranzen wie bei Front-End-Halbleiterfertigungsprozessen. Dieser Trend führt auch dazu, dass die hochpräzise Messtechnik eine zentralere Rolle bei der Kontrolle des Alignments beim Hybridbonden und der Prozessausbeute einnimmt, was wiederum die Integration von D2W-Bonding- und Metrologie-Prozessen in eine Prozesslinie vorantreibt.
Darüber hinaus werden derzeit mehrere verschiedene D2W Hybrid-Bonding-Verfahren evaluiert, die jeweils spezielle Vorteile und Anforderungen mit sich bringen. Seit seiner Einrichtung vor zwei Jahren spielt das HICC von EVG eine Schlüsselrolle zur Unterstützung von Kunden und Partnern bei der Entwicklung und Optimierung von D2W Hybrid-Bondprozessen, um die besonderen Anforderungen des jeweiligen Bauteildesigns und der jeweiligen Anwendung zu erfüllen. Hierbei müssen verschiedenste Faktoren wie die Größe der Dies, deren Dicke, die Gesamthöhe des Stacks sowie Schnittstellenüberlegungen wie das Design der Kontakte und deren Dichte berücksichtigt werden. Das HICC verfügt zudem über einen hochmodernen Reinraum mit Reinheitsstandards, die mit denen vieler führender Halbleiterfabs vergleichbar sind. Dadurch ist EVG in der Lage, die strengen Anforderungen für die Entwicklung von D2W- und W2W-Hybridbondprozessen in einzigartiger Weise zu unterstützen.
"Das HICC hat sich als zentraler, offener Inkubator für neuartige Prozesslösungen wie D2W-Hybrid- und Fusionsbonden etabliert", so Markus Wimplinger, Corporate Technology Development and IP Director bei EV Group. "Hochmoderne Reinräume in der EVG-Zentrale in Österreich sowie in unseren Tochtergesellschaften in den USA und Japan garantieren, dass Hybrid-Bonds mit der höchstmöglichen Ausbeute entwickelt werden können. Gleichzeitig bietet unser erstklassiges Entwicklungszentrum, das mit einem umfangreichen Portfolio an vollautomatischen Prozesslösungen ausgestattet ist, bestmögliche Voraussetzungen für eine agile und serienfertigungsnahe Prozessentwicklung. Unser Fachwissen in verschiedensten Bonding-Technologien sowie im Bereich der Prozessintegration und Messtechnik ermöglicht es unseren Kunden und Partnern, differenzierte Gesamtlösungen zu entwickeln, die problemlos auf ihre Produktionsumgebungen übertragen werden können."
Weitere Informationen zum Heterogeneous Integration Competence Center von EVG finden Sie unter: https://www.evgroup.com/de/products/process-services/heterogeneous-integration-competence-center/.
Über EV Group (EVG)
Die EV Group (EVG) ist anerkannter Technologie- und Marktführer für Präzisionsanlagen und Prozesslösungen zur Waferbearbeitung in der Halbleiterindustrie, Mikrosystemtechnik und Nanotechnologie. Zu den Kernprodukten gehören Waferbonder, Systeme zur Dünnwafer-Bearbeitung, Lithographie- und Nanoprägelithographie-Systeme sowie Fotoresist-Belacker, Reinigungs- und Metrologiesysteme. Das 1980 gegründete Unternehmen mit Hauptsitz in St. Florian am Inn (Austria) beschäftigt mehr als 1100 Mitarbeiter und betreut mit eigenen Niederlassungen in USA, Japan, Korea, China und Taiwan sowie Repräsentanzen namhafte Produktionskunden und R&D-Partner in aller Welt. Mehr Informationen unter www.EVGroup.com.
Kontakte:
Clemens Schütte
Director, Marketing and Communications
EV Group
Tel: +43 7712 5311 0
E-mail: Marketing@EVGroup.com
David Moreno
Principal
Open Sky Communications
Tel: +1.415.519.3915
E-mail: dmoreno@openskypr.com