DI Erich Thallner Strasse 1
4782 St. Florian am Inn
Austria
- Produkte
-
Technologien
- IR LayerRelease™ Technology
- MLE™ - Maskless Exposure Technologie
- Nanopräge-Lithographie (NIL) - SmartNIL®
- Wafer-Level Optics
- Optische Lithographie
- Fotolackverarbeitung
- Temporäres Bonden und De-Bonden
- Eutektisches Bonden
- Transient Liquid Phase (TLP) Bonden
- Anodisches Bonden
- Metall-Diffusionsbonden
- Hybrid- und Fusionsbonden
- Die-to-Wafer Fusion and Hybrid Bonding
- ComBond® Technologie
- Metrologie
- Unternehmen
- Karriere
EV Group treibt die 3D-IC Packaging Roadmap durch bahnbrechende Waferbonding-Technologie voran
Der neue SmartView® NT3 Aligner im GEMINI® FB XT Fusion Bonder ermöglicht um den Faktor 2 bis 3 verbesserte Waferbond-Alignment- und Overlay-Performance gegenüber der vorherigen Generation
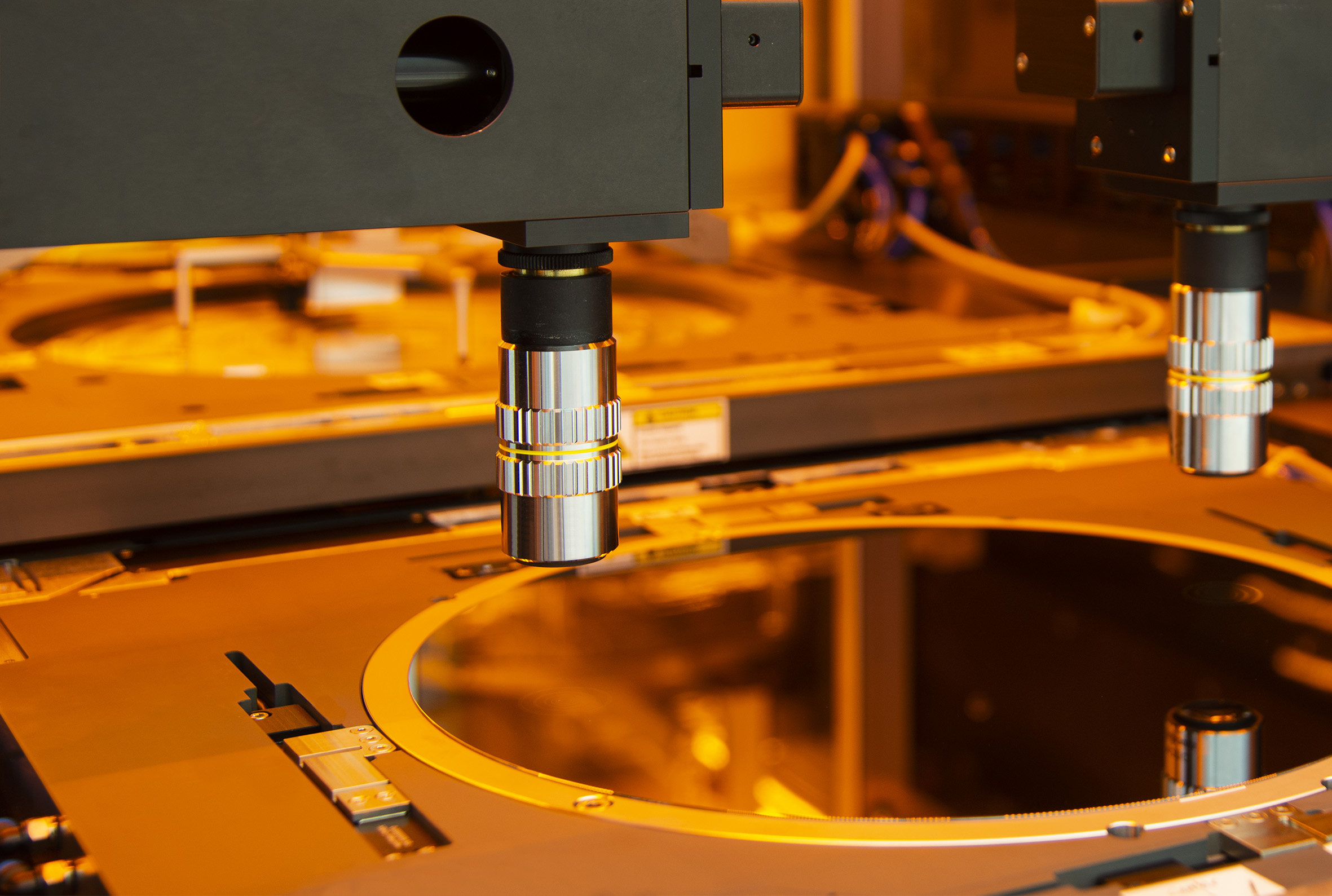
SmartView® NT3 Aligner
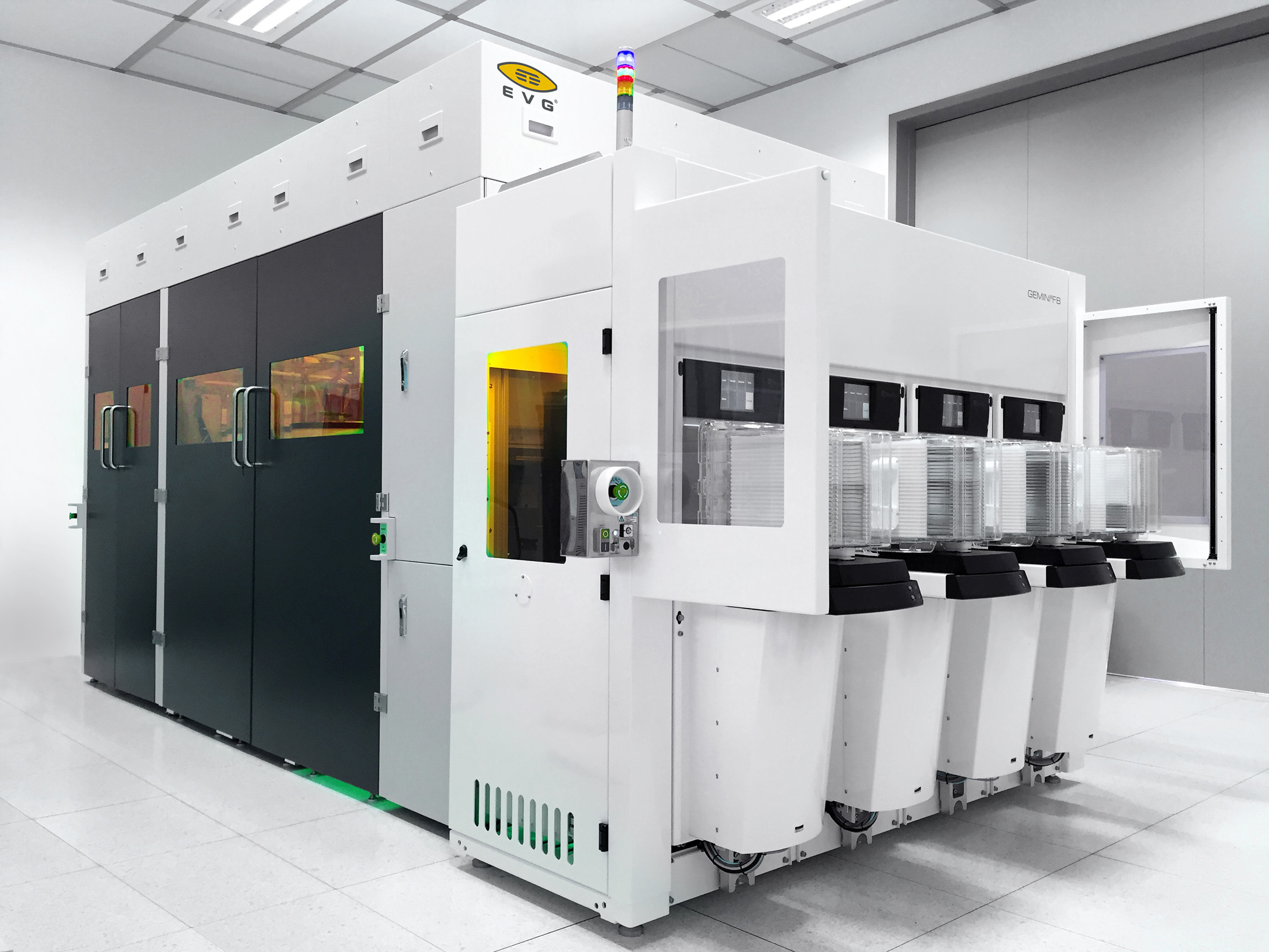
GEMINI®FB XT Automated Production Fusion Bonding System
ST. FLORIAN, Austria, 3. Juli 2018 — EV Group (EVG), ein führender Entwickler und Hersteller von Anlagen für Waferbonding- und Lithographieanwendungen in der Halbleiterindustrie, Mikrosystemtechnik und Nanotechnologie, stellte heute den neuen SmartView® NT3 Aligner vor, der ab sofort im industrieweit führenden, vollintegrierten GEMINI® FB XT Fusion Bonder für die Hochvolumenfertigung verfügbar ist. Der SmartView NT3 Aligner wurde speziell für Fusion und Hybrid Wafer Bonding Anwendungen entwickelt und bietet eine Wafer-to-Wafer Alignmentgenauigkeit von unter 50 nm, was eine Verbesserung um den Faktor 2 bis 3 darstellt. Darüber hinaus wird mit bis zu 20 Wafern pro Stunde ein deutlich höherer Durchsatz gegenüber der Vorgängerplattform erreicht.
Mit dem neuen SmartView NT3 Aligner bietet der GEMINI FB XT IDMs, Foundries und OSATs eine industrieweit unerreichte Waferbonding-Performance und ermöglicht ihnen, ihre zukünftigen 3D-IC Packaging-Anforderungen zu erfüllen. Zu den Anwendungen, die durch den weiter verbesserten GEMINI FB XT ermöglicht werden, gehören Memory Stacking, 3D Systems on Chip (SoC), Backside-illuminated CMOS Image Sensor Stacking und Die Partitioning.
Wafer Bonding als zentraler Prozess für das Stapeln von 3D-Devices
Das vertikale Stapeln bzw. Stacking von Halbleiterbausteinen setzt sich immer mehr als ein gangbarer Weg zur kontinuierlichen Erhöhung der Packungsdichte und Leistungssteigerung durch. Wafer-to-Wafer Bonding ist dabei ein wesentlicher Prozessschritt, um dreidimensional gestapelte Devices zu ermöglichen. Hierbei ist allerdings eine sehr hohe Alignment- und Overlay-Genauigkeit zwischen den Wafern erforderlich, um einen guten elektrischen Kontakt innerhalb der miteinander verbundenen Devices auf den gebondeten Wafern zu erreichen und die Kontaktflächen im Bond-interface zu minimieren und dadurch mehr Fläche für die die Herstellung der eigentlichen Devices zu schaffen. Die kontinuierliche Verkleinerung der Kontakt-Abstände, die zur Unterstützung der Roadmaps wichtiger Komponenten notwendig ist, treibt die Entwicklung immer strengerer Spezifikationen für das Wafer-to-Wafer Bonding mit jeder Produktgeneration weiter voran.
"Bei imec glauben wir an die Macht der 3D-Technologie, der Halbleiteridustrie neue Möglichkeiten und Chancen zu eröffnen und verwenden sehr viel Energie auf ihre Weiterentwicklung," sagte Eric Beyne, imec Fellow und Program Director 3D System Integration. "Ein Gebiet, auf das wir einen besondern Fokus legen, ist das Wafer-to-Wafer Bonding. Hier erzielen wir, auch durch unsere Arbeit mit Industriepartnern wie EV Group, exzellente Ergebnisse. Letztes Jahr ist es uns gelungen, den Abstand bzw. Pitch zwischen den Chip-Verbindungen beim Hybrid Wafer-to-Wafer Bonding auf 1,4 Mikrometer zu verringern - viermal kleiner als der aktuelle Pitch-Standard in der Industrie. Dieses Jahr arbeiten wir daran, den Pitch noch einmal mindestens um die Hälfte zu verringern."
"Das GEMINI FB XT Fusion Bonding System von EVG war in der Industrie schon immer führend, da es die Leistungsanforderungen für Advanced Packaging-Anwendungen nicht nur erfüllt. Wir übertreffen diese Anforderungen sogar und konnten alleine im letzten Jahr mit mehreren Industriepartnern wichtige Meilensteine bei der Overlay-Genauigkeit erreichen," sagte Paul Lindner, Executive Technology Director bei EV Group. "Mit dem neuen SmartView NT3 Aligner, der speziell für den Direct Bonding-Markt und unseren weltweit etablierten GEMINI FB XT Fusionsbonder entwickelt wurde, definiert EVG wieder einmal aufs Neue, was mit Waferbonden möglich ist. So helfen wir der Industrie, die Grenzen des Machbaren bei gestapelten Devices mit steigender Packungsdichte und Leistung sowie niedrigerem Stromverbrauch und kleinerem Footprint noch weiter zu verschieben."
Der GEMINI FB XT Fusionsbonder mit dem neuen SmartView NT3 Aligner ist für Kunden-Vorführungen und Tests verfügbar. Mehr Informationen zum Produkt finden Sie hier.
EVG wird den GEMINI FB XT mit dem neuen SmartView NT3 Aligner sowie sein umfassendes Lösungsportfolio im Bereich Waferbonden, Lithographie und Resistverarbeitung für Advanced Packaging-Anwendungen vom 10.-12. Juli auf der SEMICON West zeigen (Moscone Convention Center, San Francisco, Stand-Nr. #623 / South Hall).
Darüber hinaus wird Dr. Thomas Uhrmann, Director of Business Development von EV Group, den GEMINI FB XT und andere Entwicklungen im Bereich Wafer Bonding in seiner Präsentation "Collective Bonding for Heterogeneous Integration in Advanced Packaging" in den Mittelpunkt stellen (Donnerstag, 12. Juli 2018, 15:00-15:30 Uhr / Meet the Experts Theater, Smart Manufacturing Pavilion, SEMICON West South Hall).
About EV Group (EVG)
EV Group (EVG) is a leading supplier of equipment and process solutions for the manufacture of semiconductors, microelectromechanical systems (MEMS), compound semiconductors, power devices and nanotechnology devices. Key products include wafer bonding, thin-wafer processing, lithography/nanoimprint lithography (NIL) and metrology equipment, as well as photoresist coaters, cleaners and inspection systems. Founded in 1980, EV Group services and supports an elaborate network of global customers and partners all over the world. More information about EVG is available at www.EVGroup.com.
Contacts:
Clemens Schütte
Director, Marketing and Communications
EV Group
Tel: +43 7712 5311 0
E-mail: Marketing@EVGroup.com
David Moreno
Principal
Open Sky Communications
Tel: +1.415.519.3915
E-mail: dmoreno@openskypr.com
Hinweis für Redakteurinnen und Redakteure: Information zu in letzter Zeit erzielten Leistungssprüngen im Bereich Wafer Bonding, die von EVG und seinen Industriepartnern ermöglicht wurden, finden Sie u.a. in der folgenden Pressemitteilung: Imec and EVG demonstrate for the first time 1.8μm pitch overlay accuracy for wafer bonding