DI Erich Thallner Strasse 1
4782 St. Florian am Inn
Austria
- Produkte
-
Technologien
- IR LayerRelease™ Technology
- MLE™ - Maskless Exposure Technologie
- Nanopräge-Lithographie (NIL) - SmartNIL®
- Wafer-Level Optics
- Optische Lithographie
- Fotolackverarbeitung
- Temporäres Bonden und De-Bonden
- Eutektisches Bonden
- Transient Liquid Phase (TLP) Bonden
- Anodisches Bonden
- Metall-Diffusionsbonden
- Hybrid- und Fusionsbonden
- Die-to-Wafer Fusion and Hybrid Bonding
- ComBond® Technologie
- Metrologie
- Unternehmen
- Karriere
EV Group stellt auf der ECTC 2019 Waferbonding-Lösungen für Heterogene Integration und Wafer-Level Packaging in den Mittelpunkt
In technischen Papers und einer interaktiven Poster-Präsentation werden die Möglichkeiten der ComBond® Hochvakuum-Bonderplattform und der Lösungen von EVG zum Laser Debonden im Niedrigtemperaturbereich für „More than Moore“ Anwendungen aufgezeigt
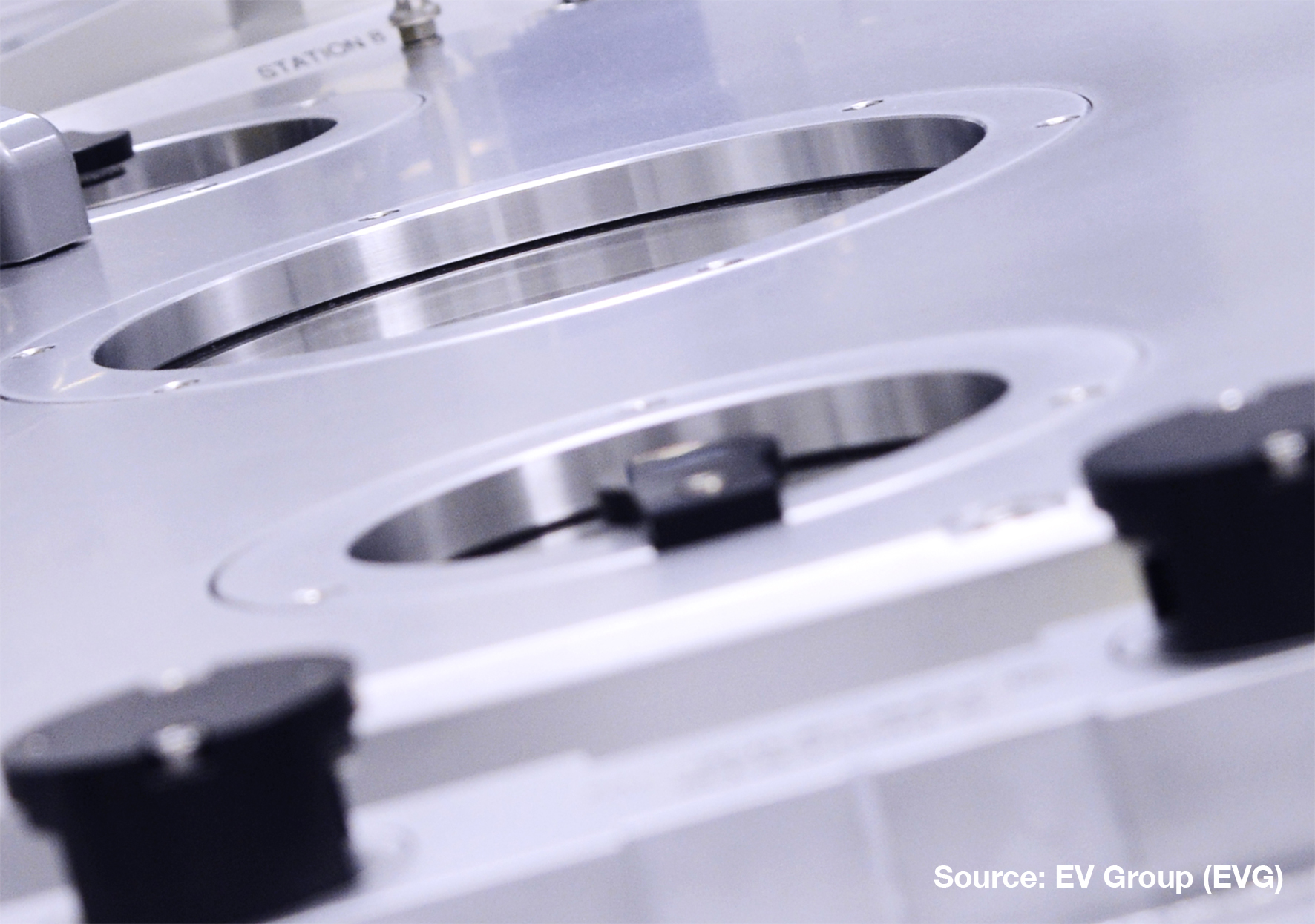
EVG ComBond® Automated High-Vacuum Bonding Platform
ST. FLORIAN, Austria, 21. Mai 2019 — EV Group (EVG), ein führender Entwickler und Hersteller von Anlagen für Waferbonding- und Lithographieanwendungen in der Halbleiterindustrie, Mikrosystemtechnik und Nanotechnologie, stellt auf der bevorstehenden IEEE 69th Electronic Components and Technology Conference (ECTC) neueste Entwicklungen im Bereich Heterogene Integration und Wafer-Level Packaging in den Mittelpunkt, die durch zukunftsweisende Waferbonding-Lösungen des Unternehmens ermöglicht werden. EVG ist als Co-Autor an mehreren technischen Publikationen und Postern beteiligt, die vom 28.-31. Mai 2019 auf der ECTC in Las Vegas präsentiert werden.
- “Optimization of a BEOL Aluminum Deposition Process Enabling Wafer Level Al-Al Thermo-Compression Bonding” (Session 5 - Wednesday, May 29, 10:25am)
This joint paper by EVG, IHP - Innovations for High Performance Microelectronics, and Sabanci University, describes a wafer-level aluminum-aluminum (Al-Al) thermo-compression bonding process used in combination with an optimized Al sputter-deposition process. Surface treatment and subsequent bonding are both performed in a high vacuum cluster via the EVG ComBond® automated high-vacuum bonding system, which provides oxide-free direct bonding of “anything on anything”.
- “Al-Al Direct Bonding with Sub-μm Alignment Accuracy for Millimeter Wave SiGe BiCMOS Wafer Level Packaging and Heterogeneous Integration” (Session 20 - Thursday, May 30, 4:45pm)
This joint paper by EVG, IHP - Innovations for High Performance Microelectronics, and Sabanci University, examines the use of the EVG ComBond system to enable Al-Al direct bonding with high alignment accuracy and reduced process temperatures to enable low-cost, fine-pitch wafer-to-wafer interconnections supporting high-performance mm-wave SiGe BiCMOS wafer-level packaging.
- “Ultra-thin QFN-Like 3D Package with 3D Integrated Passive Devices”
(Interactive Poster Session - Wednesday, May 29, 9:00 – 11:00am and 2:00 – 4:00pm)
This interactive joint poster paper by EVG, 3DiS Technologies, Besi, and NXP Semiconductors, describes the development of a novel ultra-thin, substrate-less package that integrates ultra-thin 3D stacked dies and compact 3D inductive devices inside. The work involves the use of EVG’s laser debonding solution, which combines a solid-state UV laser and proprietary beam-shaping optics to enable optimized, force-free debonding.
Die Waferbonding-, Lithographie- und Metrologielösungen von EVG ermöglichen die Entwicklung und Hochvolumenproduktion technischer Innovationen im Bereich Advanced Packaging, wie z.B. rückseitig belichtete CMOS Bildsensoren und andere, dreidimensional gestapelte Devices, sowie in den Bereichen MEMS und Verbundhalbleiter (wie z.B. Silicon Photonics und technische Substrate). EVG unterstrich seine technologische Führerschaft im Bereich Heterogene Integration und Wafer-Level Packaging zuletzt u.a. durch wegweisende Entwicklungen im Bereich Laser-Debonding für Fan-out Wafer Level Packaging (FO-WLP), Bond-Alignment-Verfahren für zukünftige Anforderungen im Bereich 3D-Integration, Fusion Bonding für Layer-Transferprozesse im Front-End-Bereich sowie Nanopräge-Lithographie für Wafer-Level Optics (WLO).
Über EV Group (EVG):
Die EV Group (EVG) ist anerkannter Technologie- und Marktführer für Präzisionsanlagen und Prozesslösungen zur Waferbearbeitung in der Halbleiterindustrie, Mikrosystemtechnik und Nanotechnologie. Zu den Kernprodukten gehören Waferbonder, Systeme zur Dünnwafer-Bearbeitung, Lithographie- und Nanoprägelithographie-Systeme sowie Fotoresist-Belacker, Reinigungs- und Metrologiesysteme. Das 1980 gegründete Unternehmen mit Hauptsitz in St. Florian am Inn (Austria) beschäftigt mehr als 850 Mitarbeiter und betreut mit eigenen Niederlassungen in USA, Japan, Korea, China und Taiwan sowie Repräsentanzen namhafte Produktionskunden und R&D-Partner in aller Welt. Für mehr Informationen siehe www.EVGroup.com.
Kontakte:
Clemens Schütte
Director, Marketing and Communications
EV Group
Tel: +43 7712 5311 0
E-mail: Marketing@EVGroup.com
David Moreno
Principal
Open Sky Communications
Tel: +1.415.519.3915
E-mail: dmoreno@openskypr.com
Am EVG-Stand #409 können die Konferenzteilnehmer der ECTC 2019 (28.-31. Mai, The Cosmopolitan of Las Vegas) mehr über EVGs breites Produkt- und Lösungsportfolio aus den Bereichen Waferbonding, Lithographie und Metrologie für Heterogene Integration und Wafer-Level Packaging erfahren.