DI Erich Thallner Strasse 1
4782 St. Florian am Inn
Austria
- Produkte
-
Technologien
- IR LayerRelease™ Technology
- MLE™ - Maskless Exposure Technologie
- Nanopräge-Lithographie (NIL) - SmartNIL®
- Wafer-Level Optics
- Optische Lithographie
- Fotolackverarbeitung
- Temporäres Bonden und De-Bonden
- Eutektisches Bonden
- Transient Liquid Phase (TLP) Bonden
- Anodisches Bonden
- Metall-Diffusionsbonden
- Hybrid- und Fusionsbonden
- Die-to-Wafer Fusion and Hybrid Bonding
- ComBond® Technologie
- Metrologie
- Unternehmen
- Karriere
EV Group enthüllt wegweisende Laser Debonding Lösung im Niedrigtemperaturbereich für Fan-out Wafer-Level Packaging
EVG kombiniert UV-Festkörperlaser, proprietäre Optik, modulare Plattform und universellen Debonding-Prozess zu einer Debonding-Technologie für FoWLP mit hohem Durchsatz und niedrigen Gesamtkosten

EVG Laser Debonding Module
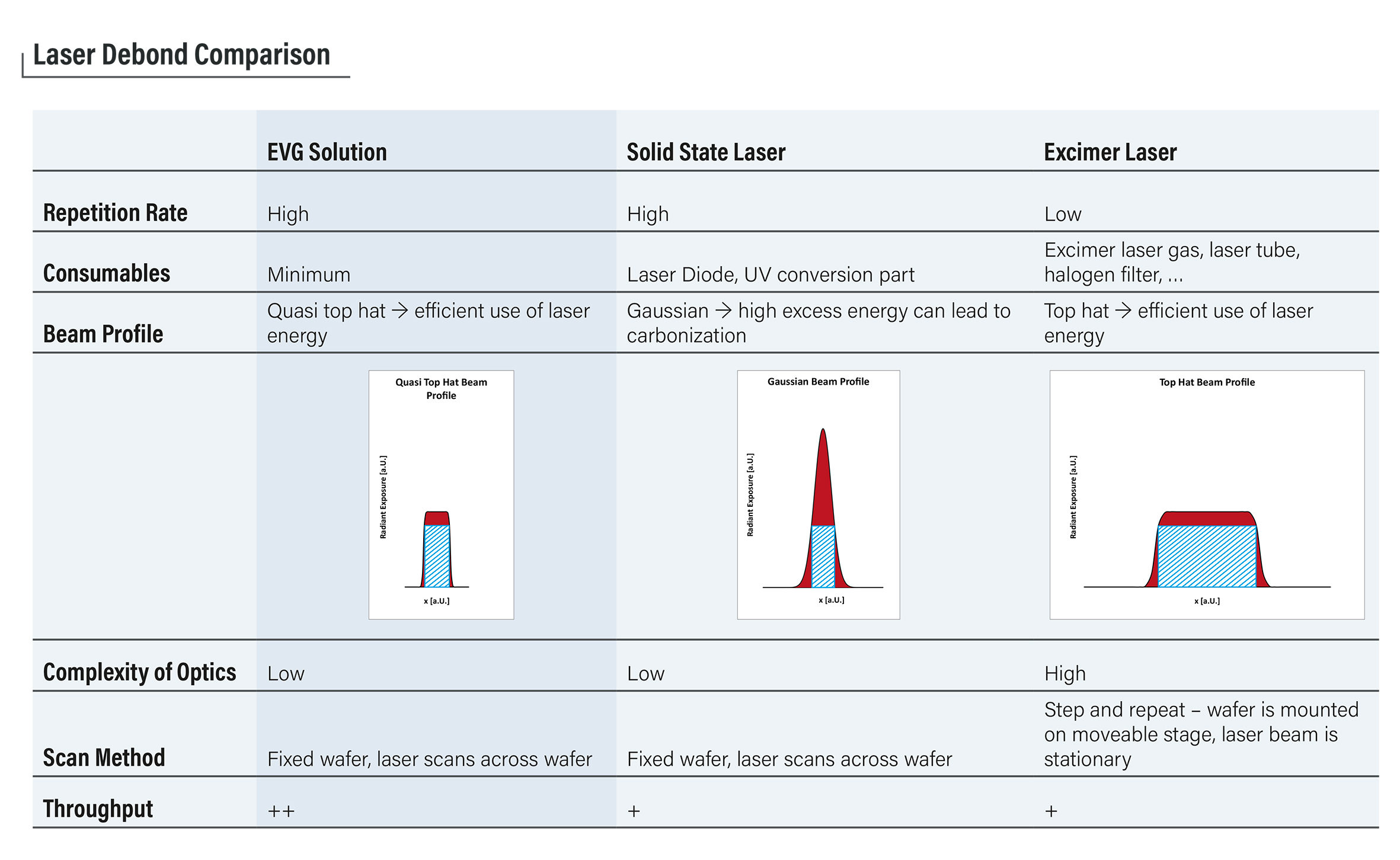

EVG®850 DB mit integriertem Filmframe Mounter
ST. FLORIAN, Austria, 5. Juli 2017 – EV Group (EVG), ein führender Entwickler und Hersteller von Anlagen für Waferbonding- und Lithographieanwendungen in der Halbleiterindustrie, Mikrosystemtechnik und Nanotechnologie, enthüllte heute die neueste Generation seiner Laser Debonding Lösungen, mit der das Debonden ultradünner, gestapelter Fan-Out Packages bei Raumtemperatur mit hohem Durchsatz und niedriger Cost of Ownership ermöglicht wird. Entwickelt als Modul zur Integration in die richtungsweisenden, automatischen Systeme des Unternehmens vom Typ EVG®850 DB, basiert die neue Laser Debonding Lösung auf einem Festkörperlaser und verwendet eine proprietäre Optik zur Strahlformung, um ein optimiertes Debonden ohne Krafteinwirkung zu ermöglichen. EVGs neue Lösung zeichnet sich sowohl durch Debonden bei niedrigen Temperaturen als auch durch Stabilität bei Hochtemperatur-Prozessen aus und eignet sich damit nicht nur ideal für das Fan-Out Wafer-Level Packaging (FoWLP), sondern auch für die Bearbeitung von Verbindungshalbleitern und Leistungsbauteilen. Für die neue Lösung liegen bereits mehrere Kundenaufträge vor.
"Die Halbleiterindustrie und die mit ihr zusammenhängenden Bereiche entwickeln sich von Tag zu Tag schneller in verschiedenste Richtungen. Das Internet der Dinge, Fortschritte im Automotive-Bereich, der Bereich Kommunikation und virtuelle Anwendungen werden heutzutage alle vom Fortschritt in dieser Industrie beflügelt," sagte Paul Lindner, Executive Technology Director bei EV Group. "Viele dieser Entwicklungen finden aktuell auf der Packaging-Ebene statt, wo die Nachfrage nach größerer Funktionalität der Devices und kleineren Baugrößen zu immer komplexeren Packages, gestapelten Packages, Systems in Package sowie Hochleistungs-Packages geführt hat. EVGs Temporary Bonding und Debonding Lösungen, zu denen unser Laser Debonding Modul der neuesten Generation zählt, spielen eine wichtige Rolle wenn es darum geht, dünne Wafer zur Erreichung kleinerer Baugrößen für diese neuen Packaging-Architekturen und Anwendungen sowie deren Bearbeitung zu ermöglichen."
FoWLP bietet die Voraussetzungen, um sehr dünne Devices und die Systemintegration mit gestiegener Leistung, Funktionalität und Designflexibilität für Produkte der Unterhaltungselektronik und Mobilelektronik zu ermöglichen. Laut der Marktforschungs- und Strategieberatungsfirma Yole Développement wird FoWLP von 2017 bis 2022 mit einer kumulierten, jährlichen Wachstumsrate (CAGR) von 36 Prozent wachsen und im Jahr 2022 einen Wert von 3 Mrd. $ erreichen.* Die extrem dünnen Device-Wafer beim FoWLP treiben die Nachfrage nach Technologien voran, bei denen temporäre Substratträger zum Einsatz kommen. Beim FoWLP-Ansatz "Chip last / Redistribution Layer (RDL) first" findet der gesamte Package-Durchlauf auf einem Glaswafer oder Glaspanel statt. Nachdem der RDL-Layer direkt über dem Debonding-Layer liegt ist ein Debond-Prozess notwendig, der mit geringer Krafteinwirkung auskommt, um das Risiko einer niedrigeren Produktionsausbeute zu minimieren. Um den Glasträger nach der RDL-Formation zu entfernen ist Laser-Debonden ideal, da es nur minimale Kräfte erfordert. Darüber hinaus lassen sich aufgrund der Temperatur-Stabilität des Laser Debonding Prozesses die Bondmaterialien einfach entfernen, ohne andere Materialien im Package zu beeinflussen. Das führt zu einem niedrigen Bruchrisiko für den Devicewafer und zu einer hohen Produktionsausbeute.
Umfassende Weiterentwicklungen für verbesserte Produktionsausbeute und Cost of Ownership
EVGs neue Laser Debonding Lösung basiert auf einem UV-Festkörperlaser und einem proprietären optischen Aufbau, durch den das Gauss'sche Strahlenprofil des Lasers in eine Zylinderhut-ähnliche Form gebracht wird. Durch diesen optischen Aufbau erreicht EVG einen sehr gut reproduzierbaren und räumlich kontrollierten Strahl, womit die in den Devicewafer eingebrachte Hitze minimiert wird. Dies ermöglicht eine genauere Prozessüberwachung, was in Verbindung mit der hohen Pulsrate des Lasers, der Beeinflussbarkeit des Laserstrahls, die Laser-Bearbeitung und Wafer-Ablösung in der gleichen Kammer zur Reduzierung der Handling-Zeit sowie der Fähigkeit, die gesamte Oberfläche eines feststehenden Wafers mit dem Laser zu scannen zu einem sehr gut kontrollierbaren Niedrigtemperatur-Debonding Prozess mit hohem Durchsatz führt.
Die Kostenvorteile des Systems werden nicht zuletzt auch durch den geringen Wartungsaufwand des Lasers, die lange Lebensdauer der Carrier-Wafer, die Fähigkeit, vollautomatische Filmframes, übergroße Carrier oder selbsttragende, nicht unterstützte Dünnwafer zu verarbeiten sowie das optimierte Layout mit geringem Footprint abgerundet. In der Tradition von EVG, auch im Waferbondingbereich offene Plattformen zu bieten, ist die neue Laser Debonding Lösung zudem mit einer Vielzahl kommerziell erhältlicher Adhesive-Materialien kompatibel.
Produktvorführungen der neuen Laser Debonding Lösung sind jederzeit in den Reinräumen von EVG möglich. Darüber hinaus wird EVG seine neue Lösung zusammen mit dem kompletten Portfolio von Waferbonding-, Lithographie- und Resistverarbeitungslösungen für Advanced Packaging Anwendungen auf der SEMICON West zeigen, die vom 11.-13. Juli im Moscone Convention Center in San Francisco stattfindet. EVG ist auf der Messe mit einem eigenen Stand (West Hall, Stand #7211) vertreten.
Mehr Informationen zu EVGs neuer Laser-Debonding Lösung finden Sie auch hier.
Über EV Group (EVG):
Die EV Group (EVG) ist anerkannter Technologie- und Marktführer für Präzisionsanlagen und Prozesslösungen zur Waferbearbeitung in der Halbleiterindustrie, Mikrosystemtechnik und Nanotechnologie. Zu den Kernprodukten gehören Waferbonder, Systeme zur Dünnwafer-Bearbeitung, Lithographie- und Nanoprägelithographie-Systeme sowie Fotoresist-Belacker, Reinigungs- und Metrologiesysteme. Das 1980 gegründete Unternehmen mit Hauptsitz in St. Florian am Inn (Austria) beschäftigt mehr als 850 Mitarbeiter und betreut mit eigenen Niederlassungen in USA, Japan, Korea, China und Taiwan sowie Repräsentanzen namhafte Produktionskunden und R&D-Partner in aller Welt. Für mehr Informationen siehe www.EVGroup.com.
Kontakte:
Clemens Schütte
Director, Marketing and Communications
EV Group
Tel: +43 7712 5311 0
E-mail: Marketing@EVGroup.com
David Moreno
Principal
Open Sky Communications
Tel: +1.415.519.3915
E-mail: dmoreno@openskypr.com
*Anmerkung: Die genannten Marktdaten stammen aus dem Report "Status of the Advanced Packaging Industry 2017", der von Yole Développement im Mai 2017 veröffentlicht wurde. Mehr Informationen finden Sie unter: https://www.i-micronews.com/