临时键合和解键合
Temporary bonding and debonding enabling backside processing for 3D integration
Introduction
Temporary bonding is an essential process to offer mechanical support for thin or to-be-thinned wafers, which are key for 3D IC, power device and FoWLP wafers, as well as for handling fragile substrates like compound semiconductors. EVG’s outstanding bonding know-how includes temporary bonding equipment, which has been provided by the company since 2001.
EVG’s open adhesive platform supports all commercially available materials, offering full process integration for temporary bonding and debonding. Adhesives are mainly classified by their debonding mechanism (weakening the adhesive bond between the device and carrier wafer), which is based on laser, mechanical force or temperature. Slide-off and lift-off debonding mark the starting point of temporary bonding at EVG with more than 20 years of experience. More recent developments of mechanical and UV-laser-initiated debonding are combined in EVG’s LowTemp debonding process, where the debond temperature is around room temperature. Especially for recent developments in advanced packaging, LowTemp debonding technologies are essential steps to enable back-side processing of silicon as well as the production of ultra-thin chips and packages for next-generation devices.
Features
- Open adhesive platform
- Modular tool layout – throughput optimized depending on specific process
- Bridge capability for different substrate sizes
- Available with multiple load port options and combinations
- Integrated metrology enables feedback loop for high-yield processes in automated tools
- Software monitoring of the whole process
- Fully integrated SECS/GEM interface in automated tool
Figures
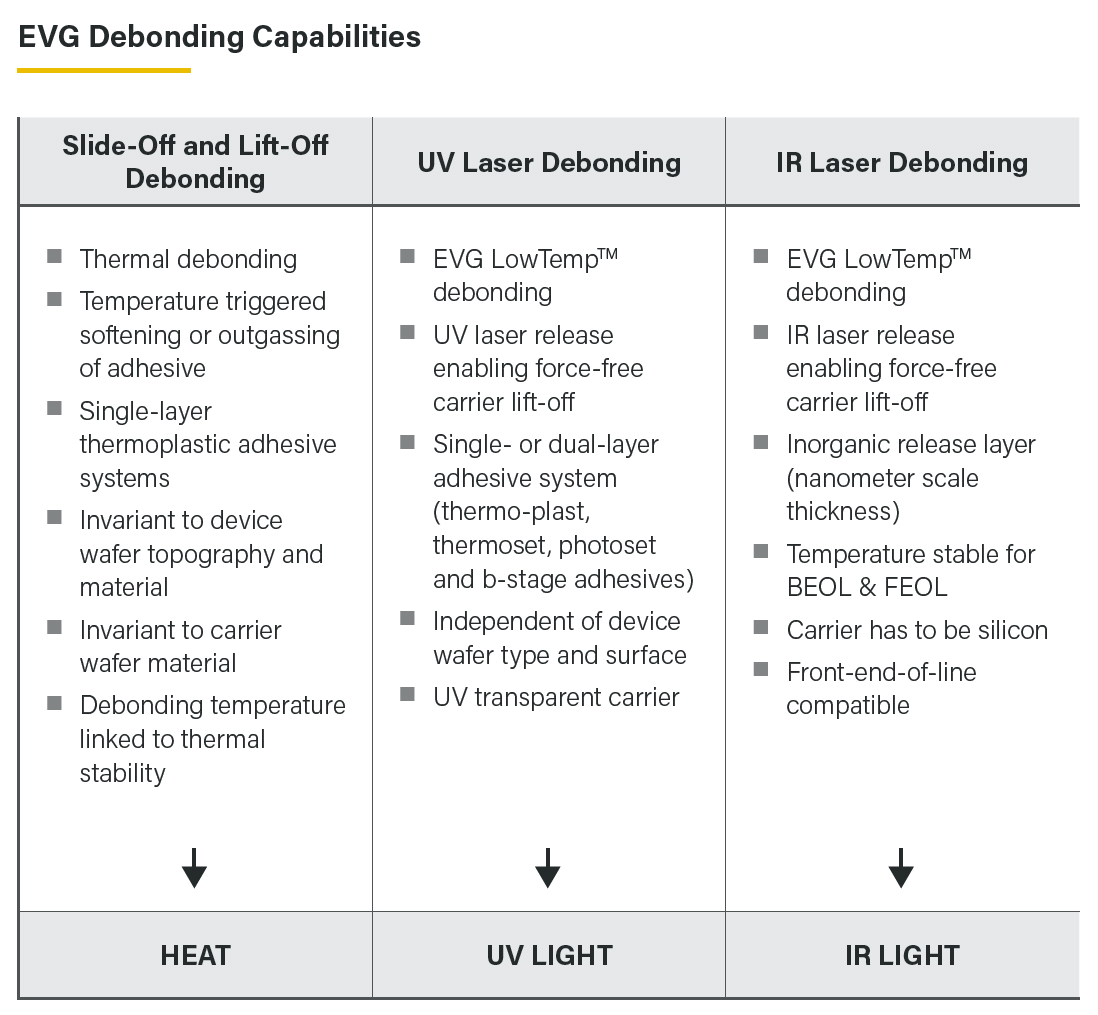
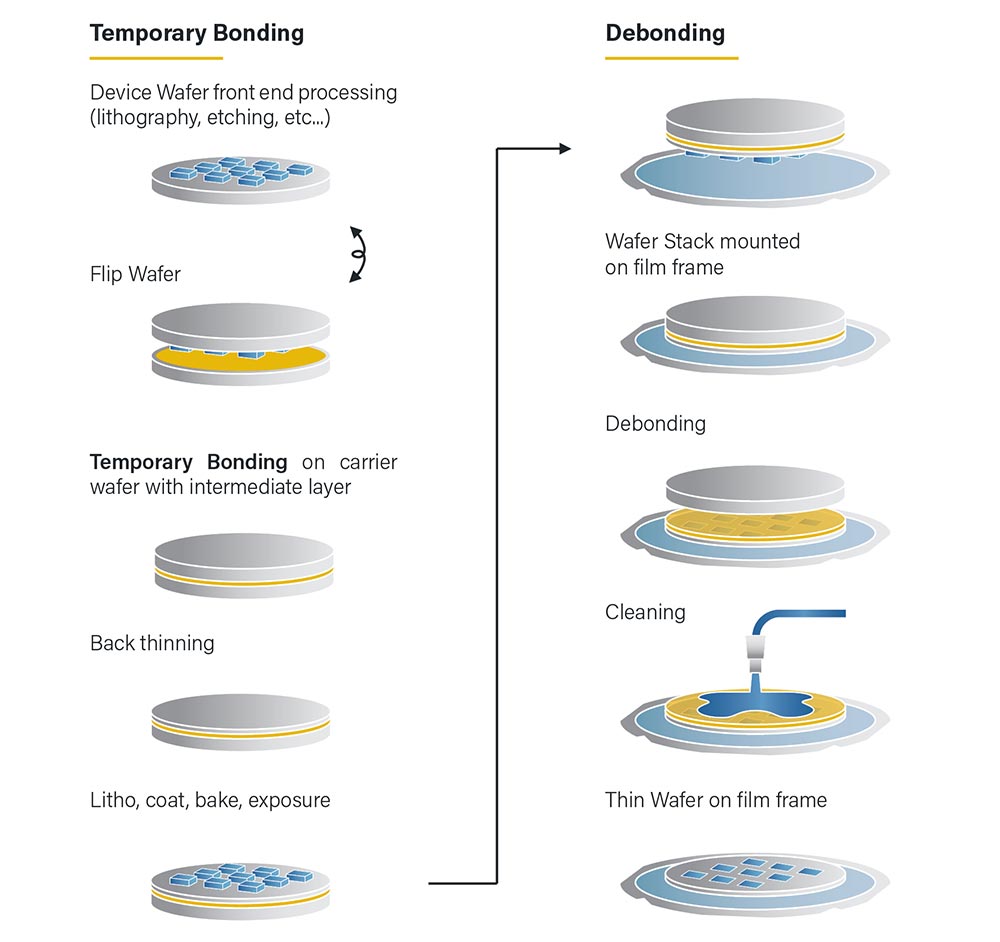
Events

EVG Technology Day 2024 in Taiwan
Register now for the EVG Technology Day in Taiwan at the Hsinchu Ambassador Hotel on April 16 ,2024!

CS / PIC / PE International Conference 2024
Visit us at our booth at the CS / PIC and PE International Conference and listen to our talks:
"Heterogenous Integration of Compound Semiconductors by W2W and D2W Bonding" held by Business Development Manager Bernd Dielacher at the CS Conference.
"Advances in PIC Manufacturing for Sensing and Datacom Applications – All Thanks to Nanoimprint Lithography" held by Business Development Manager Jonas Khan at the PIC Conference.
"Cost-effective SiC substrate manufacturing for power devices enabled by oxide-free wafer bonding" held by Business Development Manager Bernd Dielacher at the PE Conference.

ICEP 2024
Listen to our talks "Synchronization of Process and Material to Achieve Best Results in NanoImprinting Lithography" held by our Senior Process Enigeer Schuster Patrick and "Advanced Manufacturing Techniques for Freeform Micro-Optics Elements" held by our Product Manager Dr. Dudus Anna on Friday 19th April in Room "A" at 2:00PM.

Talk to our EVG technology experts!
Questions?
Related products
Questions about our technologies?
Contact the EVG experts