DI Erich Thallner Strasse 1
4782 St. Florian am Inn
Austria
EV Group、リソグラフィに革新をもたらす、新マスクレス露光技術 (MLE™) を発表
卓越した柔軟性・拡張性、所有コストベネフィットを実現するEVGの新マスクレス露光技術 (従来EVG量産リソグラフィ方式比)
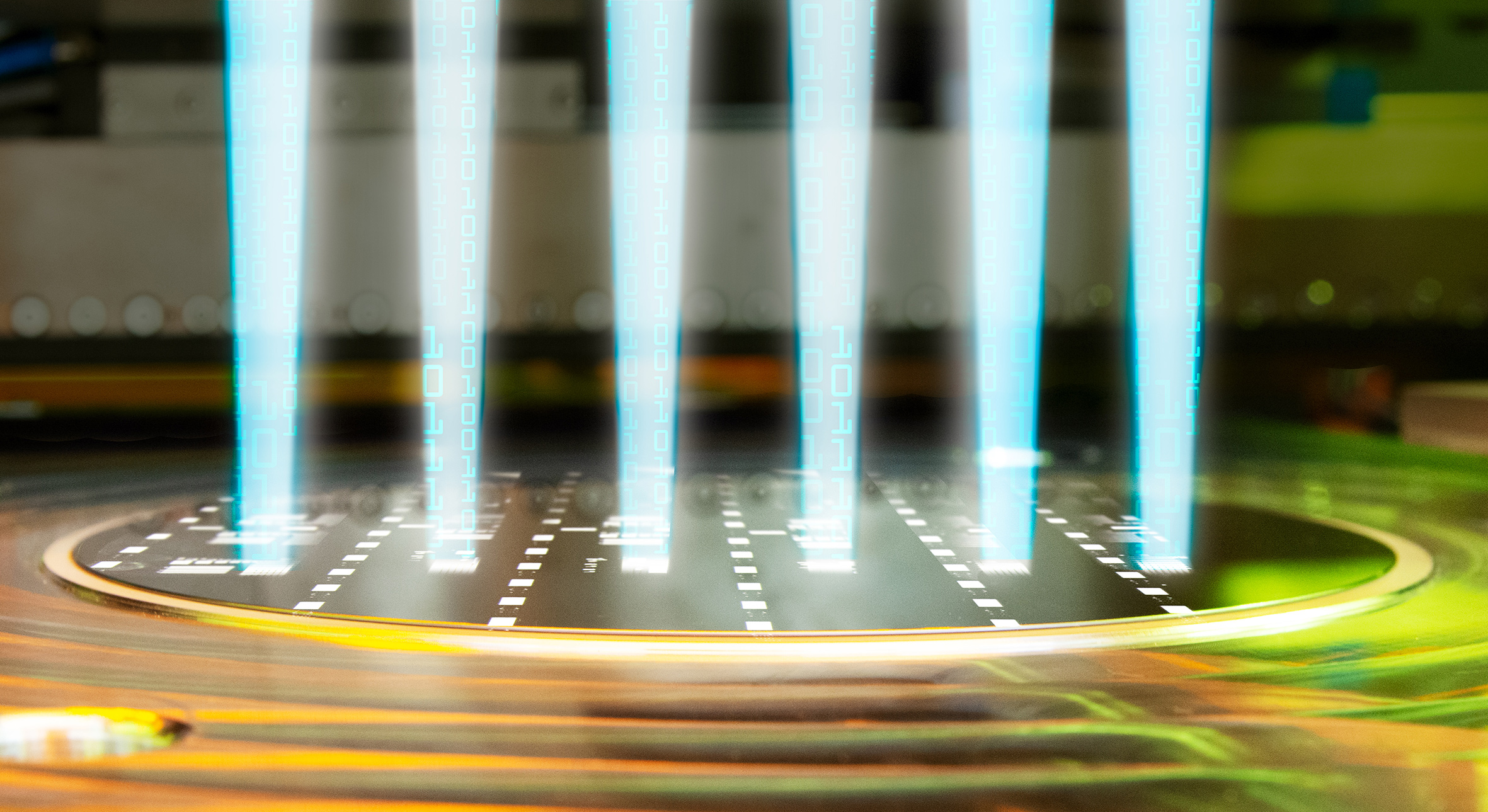
EVG MLE™ (Maskless Exposure) technology
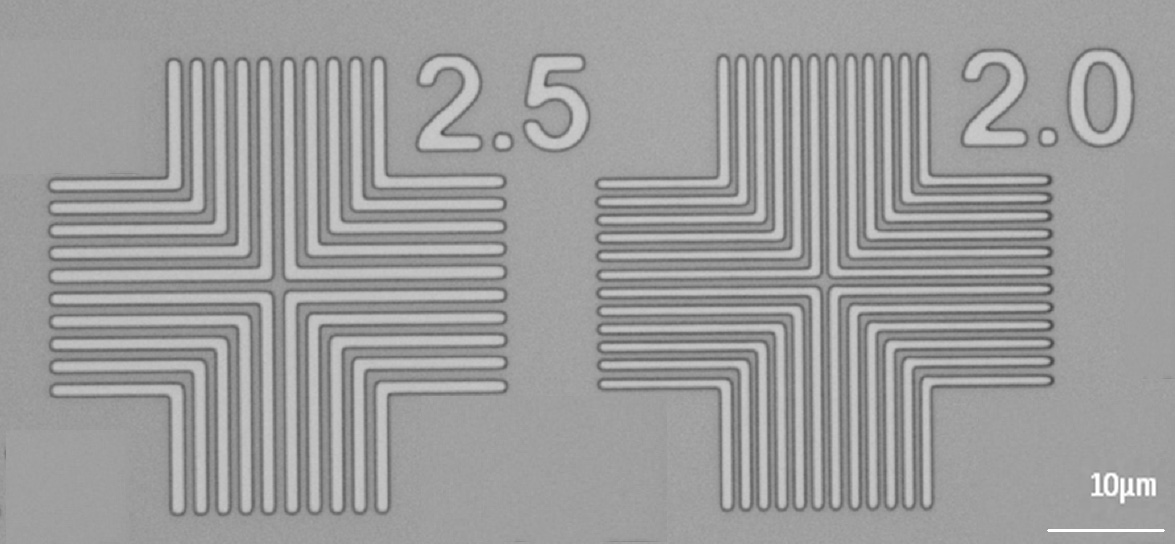
MLE™ exposure in high resolution AZ MIR 701 positive tone photoresist
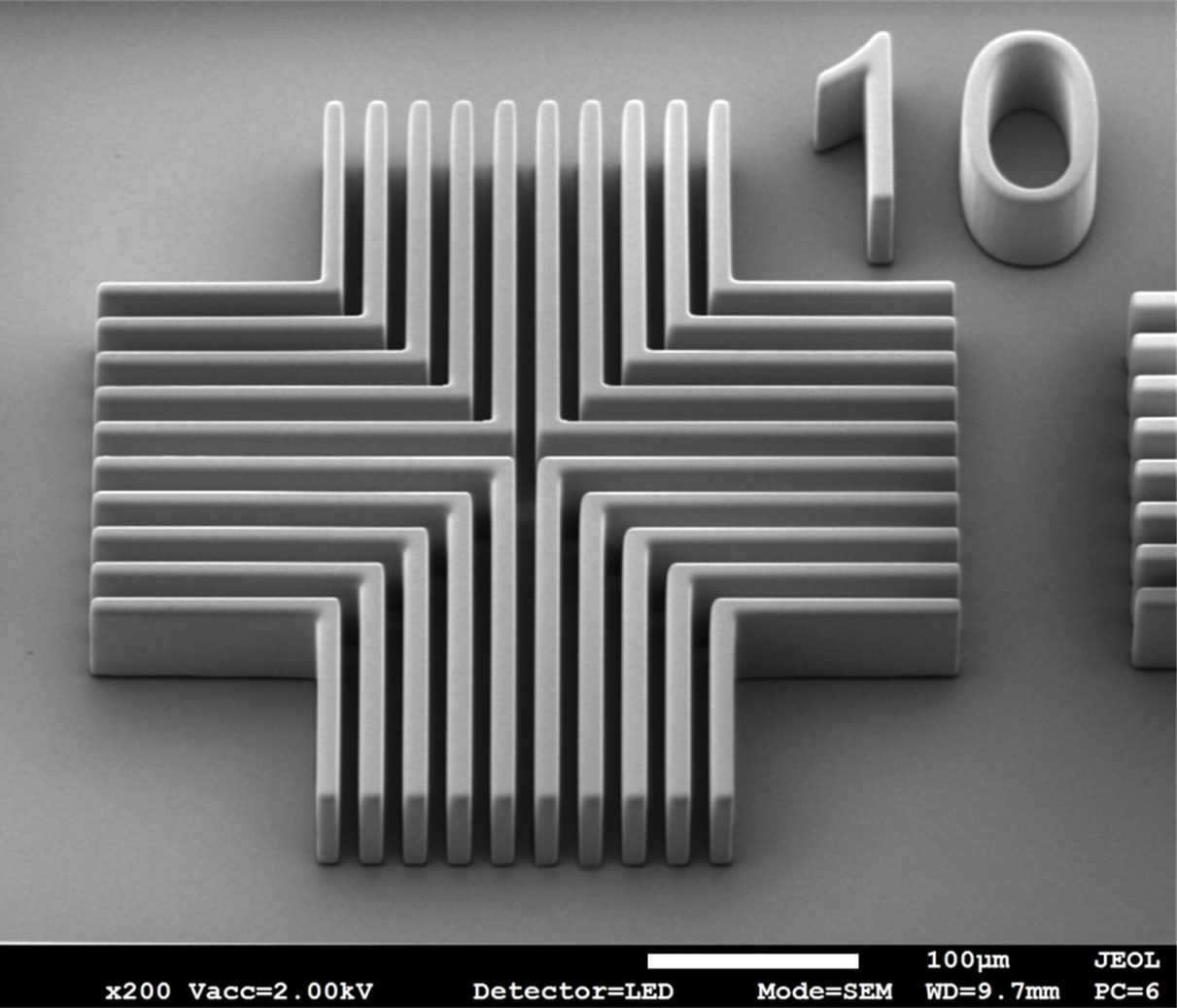
MLE™ exposure in 50 µm thick layer JSR THB 151N negative tone resist

MLE™ exposure in 600 µm thick SU8

Individual die annotation using MLE™ technology
2019年8月21日
ウェーハ接合およびリソグラフィ装置のリーディングサプライヤーであるEV Group(本社: オーストリア ザンクト・フローリアン、以下: EVG)は、革新的なリソグラフィ技術であるMLE™(マスクレス露光)を発表しました。先端パッケージング、MEMS、バイオメディカルおよび高密度プリント回路基板(PCB)等のアプリケーション向けに開発されたMLEは、バックエンドリソグラフィの次世代要求を満たし、優れた拡張性を有する業界初の量産対応マスクレスリソグラフィ技術です。高解像度のパターニング、高スループットおよび高歩留まりを実現するとともに、これまでフォトマスクの維持・管理等に必要だった間接費を大幅に削減します。 さらに、この技術の持つ類まれな柔軟性により、さまざまな需要に応え、極めて短いサイクルでお客様の新規デバイス開発を可能にします。
MLE技術は、パネルを含むあらゆるウェーハサイズに対応し、またクラスター化された書き込みヘッドと多波長高出力UV光源を適切に組み合わせることで、すべての市販のレジストを使用することができます。また、レイアウトの複雑さや解像度に影響されることなく高スループットを達成し、どのようなフォトレジストにおいても変わらず優れたパターニング性能を実現します。 MLEはEVGの既存リソグラフィ装置を補完するとともに、従来のリソグラフィ方式が拡張性や所有コスト(CoO)などの制約により適用が難しくなることを想定し、こうした場面で新たに活用し得るよう開発・設計されました。
EVGオーストリア本社にてデモンストレーションをご覧いただくことができるMLE技術ですが、近日中に現在開発中のEVG新シリーズ装置に搭載され、新製品として公式発表が行われる予定です。
EV Groupで、エグゼクティブ・テクノロジー・ディレクターを務めるポール・リンドナー(Paul Lindner)は、以下のように述べています。「当社の新しいMLE技術は、ステッパー等、他のパターニング技術では性能やコストの面で妥協せざるを得ないバックエンドリソグラフィのアプリケーションにおいて、優れた性能を発揮します。お客様はもう、バックエンドのパターニング要求に合わせて、解像度、速度、柔軟性、所有コストのいずれかのみを選ばなければならない、といった難しい選択を迫られることはありません。幅広い分野のお客様と初期開発作業を行った結果、MLE技術が寄与するアプリケーションは極めて多岐にわたり、また今後も拡大し続けることを確信しています。この独自の露光技術を製品化することにより、業界のより多くの企業様と提携し、新たなデバイスやアプリケーション開発に貢献できることを楽しみにしています」
新たな課題に直面するバックエンドリソグラフィ
ヘテロ集積化が半導体の開発と技術革新を牽引し、先端パッケージング、MEMSおよびPCB市場に影響を与えるようになるにつれて、バックエンドリソグラフィに対する要求はより厳しくなります。たとえば先端パッケージングでは、再配線層(RDL)やインターポーザーの密集ライン/スペース(L/S)が続く部分において、最小解像度に対する要求がますます厳しくなっています。場合によってそれらは2μmあるいはそれ以下が求められる一方、パターニングにはダイ配置のばらつきや費用対効果の高い樹脂基板の使用にも対応できる、より高い柔軟性も要求されます。また、さらに高度なオーバーレイ精度や、垂直側壁へのパターニングに対するより深い焦点深度への要求も高まっています。ファンアウトウェーハレベルパッケージング(FoWLP)において、ウェーハの歪みに起因するパターンの歪みやダイシフトの最小化、厚膜および薄膜レジストへの対応といった新しい要件は、既存および今後の先端パッケージングリソグラフィ装置に求められる要件のほんの一部に過ぎません。MEMS製造では、その複雑な製品構成により、マスク/レチクルにかかる間接費が所有コスト(CoO)に大きな影響を及ぼす一方、トレンチ内へのパターニングに際し優れた焦点制御は不可欠です。PCBおよびバイオメディカル分野では、幅広い加工寸法および基板サイズに対応するため、高度なパターン柔軟性に対する需要が高まっています。
MLE技術詳細
EVGのMLE技術は、基板表面全体への高解像度(<2μm L/S)および繋ぎ目の無いマスクレス露光を、高スループットと低所有コスト(CoO)で可能にします。また、お客様の要求に応じてUV露光ヘッドを追加したり取り外すことにより、装置構成を調整することができます。これは、研究開発から量産体制への迅速な移行、スループットの最適化、さまざまな基板サイズや材料への適応を可能にするとともに、小型のシリコン/化合物半導体ウェーハからパネルサイズまで、あらゆる基板を処理するのに理想的です。柔軟で拡張性の高い高出力UVレーザー光源は多波長露光をオプションで備え、フォトレジストの種類に依存しないパターニング性能を達成します。
EVGのMLE(マスクレス露光)技術の詳細については、下記ウェブサイトをご覧ください
https://www.evgroup.com/technologies/mle-maskless-lithography
EV GROUP(EVG)について
EV Group(EVG)は半導体、MEMS、化合物半導体、パワーデバイスおよびナノテクノロジーデバイスの製造装置およびプロセスソリューションのリーディングサプライヤーです。主要製品には、ウェーハ接合、薄ウェーハプロセス、リソグラフィ/ナノインプリントリソグラフィ(NIL)や計測機器だけでなく、フォトレジストコーター、クリーナー、検査装置などがあります。1980年に設立されたEVGは、グローバルなお客様および世界中のパートナーに対し緻密なネットワークでサービスとサポートを提供します。 EVGに関する詳しい情報はwww.EVGroup.comをご参照ください。
プレスの方の問い合わせ先
イーヴィグループジャパン株式会社 マーケティング担当
TEL: 045-348-0665 E-mail: Marketing+CommunicationsJapan@EVGroup.com
ミアキス・アソシエイツ 河西
TEL: 090-4376-0123 E-mail: kasai@miacis.com