DI Erich Thallner Strasse 1
4782 St. Florian am Inn
Austria
EV Groupが「More Moore」スケーリングおよびフロントエンドプロセス向け
最新装置 BONDSCALE™ により、ウェーハ接合の生産性が大幅に向上 IRDSロードマップで示されたロジックトランジスタのスケーリングと3次元集積化の課題に対応
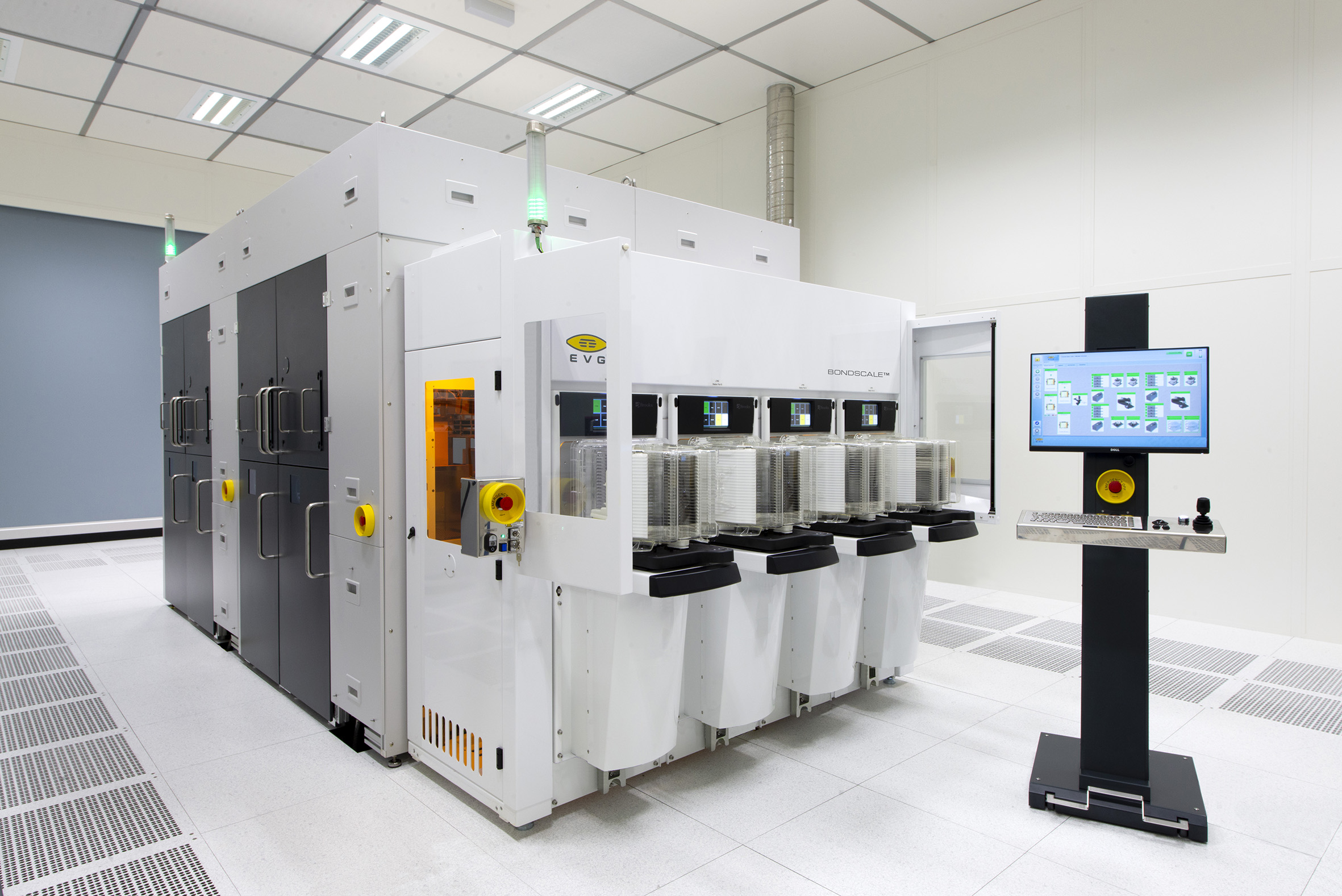
EVG BONDSCALE™

ST. FLORIAN, Austria, December 3, 2018 — MEMS、ナノテクノロジーおよび半導体分野向けウェーハ接合およびリソグラフィ装置のリーディングサプライヤーであるEV Group(EVG)は、最新の全自動フュージョン接合装置BONDSCALE™を12月3日に発表しました。 BONDSCALE™はフュージョン/分子接合の幅広いアプリケーションに対応するために設計され、先端基板製造やモノリシック3D(M3D)等、レイヤートランスファープロセスを用いた3次元集積化を可能にします。EVGはBONDSCALE™によって、ウェーハ接合技術を半導体のフロントエンドプロセスに導入し、国際デバイスおよびシステムロードマップ(IRDS)で規定された「More Moore」ロジックデバイスのスケーリングに関する長期的課題の解決に貢献します。BONDSCALE™は全く新しいエッジアライメントのコンセプトを採用し、ボイドフリー、高スループット、高歩留まりの製造プロセスを達成することでウェーハ接合の生産性を大幅に向上させると共に、所有コスト(CoO)を大幅に削減します。この装置は、すでにお客様への納入が開始されています。
BONDSCALE™は業界ベンチマークであるEVGのGEMINI®FB XT 全自動量産型フュージョン接合装置と並行して販売されますが、それは各装置が異なるアプリケーションを対象としているからです。BONDSCALE™が主に先端基板用接合とレイヤートランスファープロセスに特化しているのに対し、GEMINI®FB XTはより厳格なアライメント精度を必要とするアプリケーション、例えばメモリ積層や3Dシステムオンチップ(SoC)、積層型CMOSイメージセンサー、ダイパーティショニング等をサポートします 。
半導体性能スケーリング加速の鍵となるウェーハ直接接合
IRDSロードマップによると、寄生素子による影響の増大は今後のロジックデバイス性能を決定する主な要因となるため、新たなトランジスタ構造と材料が必要になると予想しています。またIRDSロードマップでは、2Dから3D VLSIへの長期的な移行(裏面電源配線、N&P積層、ロジック・オン・メモリ、機能クラスター積層、beyond-CMOS採用を含む)を支援する上で、モノリシック3D(M3D)等の新たな手法による3次元集積化が必須であることにも言及しています。レイヤートランスファープロセスと先端基板によって、デバイスの性能と機能および消費電力は大幅に向上し、ロジックデバイスのスケーリング則が可能になります。プラズマ活性化によるウェーハ直接接合は、異種材料のヘテロ集積化や高品質な先端基板製造、およびシリコン薄膜のレイヤートランスファーといったアプリケーションを可能にする、実証済みのソリューションです。
EV Groupのエグゼクティブ・テクノロジー・ディレクターであるポール・リンドナー(Paul Lindner)は次のように述べています。「ウェーハ接合のパイオニアでありマーケット・リーダーとして、EVGは研究開発の初期から本格的な製造に至るまで、常に最先端の半導体技術をお客様に提供しています。約25年前、高周波や耐放射線といったニッチな領域向けのデバイス製造をサポートするため、EVGは業界初のSOIウェーハ接合装置を発表いたしました。以来、弊社は直接接合プラットフォームの性能と所有コスト(CoO)を継続的に強化し、お客様が先端基板の利点をより広い範囲のアプリケーションに適用できるようサポートしてきました。『More Moore』の時代において、次世代ロジックおよびメモリデバイスの性能や消費電力および素子面積のスケーリング則を継続可能にする、先端基板とレイヤートランスファープロセスへの需要が高まっています。これに対応するため、弊社最新のBONDSCALE™ソリューションは生産性を一段と向上させ、直接接合プラットフォームを次のレベルへと引き上げました。」
BONDSCALE™は、フロントエンドアプリケーションに必要なフュージョン/直接ウェーハ接合の量産用装置です。EVGのLowTemp™プラズマ活性化技術を特長とするBONDSCALE™装置は、フュージョン接合に必要なすべての工程(洗浄、プラズマ活性化、アライメント、プリボンディング、IR検査等)を一つのプラットフォームに統合し、フュージョン/分子接合の幅広いアプリケーションに対応します。200㎜および300㎜双方のウェーハプロセスにおいて本装置は、ボイドフリー、高スループット、高歩留まりの製造プロセスを保証します。
BONDSCALE™は次世代のフュージョン/直接接合モジュール、最新のウェーハ搬送システム、光学エッジアライメントを装備し、極めて高いスループットと生産性を実現します。先端基板製造とM3Dインテグレーションにおけるお客様のニーズに対応します。
先端基板およびフロントエンドウェーハ接合向けBONDSCALE™ 全自動フュージョン接合装置に関する詳細は下記をご覧ください。
Link
<EV Groupについて>
EV Group(EVG)は半導体、MEMS、化合物半導体、パワーデバイスおよびナノテクノロジーデバイスの製造装置およびプロセスソリューションのリーディングサプライヤーです。主要製品は、ウェーハ接合、薄ウェーハプロセス、リソグラフィ/ナノインプリントリソグラフィー(NIL)や計測機器だけでなく、フォトレジストコーター、クリーナー、検査装置などがあります。1980年に設立されたEVGは、グローバルなお客様および世界中のパートナーに対し緻密なネットワークでサービスとサポートを提供します。
EVGに関する詳しい情報はwww.EVGroup.comをご参照ください。
本件に関する報道関係の方からのお問い合わせ先
Clemens Schütte
Director of Marketing & Communications EV Group
Phone: +43 7712 5311 0
E-Mail: C.Schuette@EVGroup.com
広報代理店 オグルヴィPR
担当: 長谷川/大北
Tel: 03-5793-2346/ 2345 Fax: 03-5793-2381
E-mail: chiharu.hasegawa@ogilvy.com,
hiroko.okita@ogilvy.com