DI Erich Thallner Strasse 1
4782 St. Florian am Inn
Austria
- Produkte
- Technologien
- IR Laser Cleave Technology
- MLE™ - Maskless Exposure Technologie
- Nanopräge-Lithographie (NIL) - SmartNIL®
- Wafer-Level Optics
- Optische Lithographie
- Fotolackverarbeitung
- Temporäres Bonden und De-Bonden
- Eutektisches Bonden
- Transient Liquid Phase (TLP) Bonden
- Anodisches Bonden
- Metall-Diffusionsbonden
- Fusions- und Hybridbonden
- Die-to-Wafer Fusion and Hybrid Bonding
- ComBond® Technologie
- Metrologie
- Unternehmen
- Karriere
Leti demonstriert weltweit erstmalig 300 mm Wafer-to-Wafer Hybrid Direct Bonding mit 1 Mikrometer Pitch auf System von EV Group
Neuer Pitch-Rekord beim hybriden Kupfer-Bonden mit herausragender Wafer-to-Wafer Overlay-Genauigkeit stellt einen Durchbruch für 3D-IC-Anwendungen mit hoher Packungsdichte dar
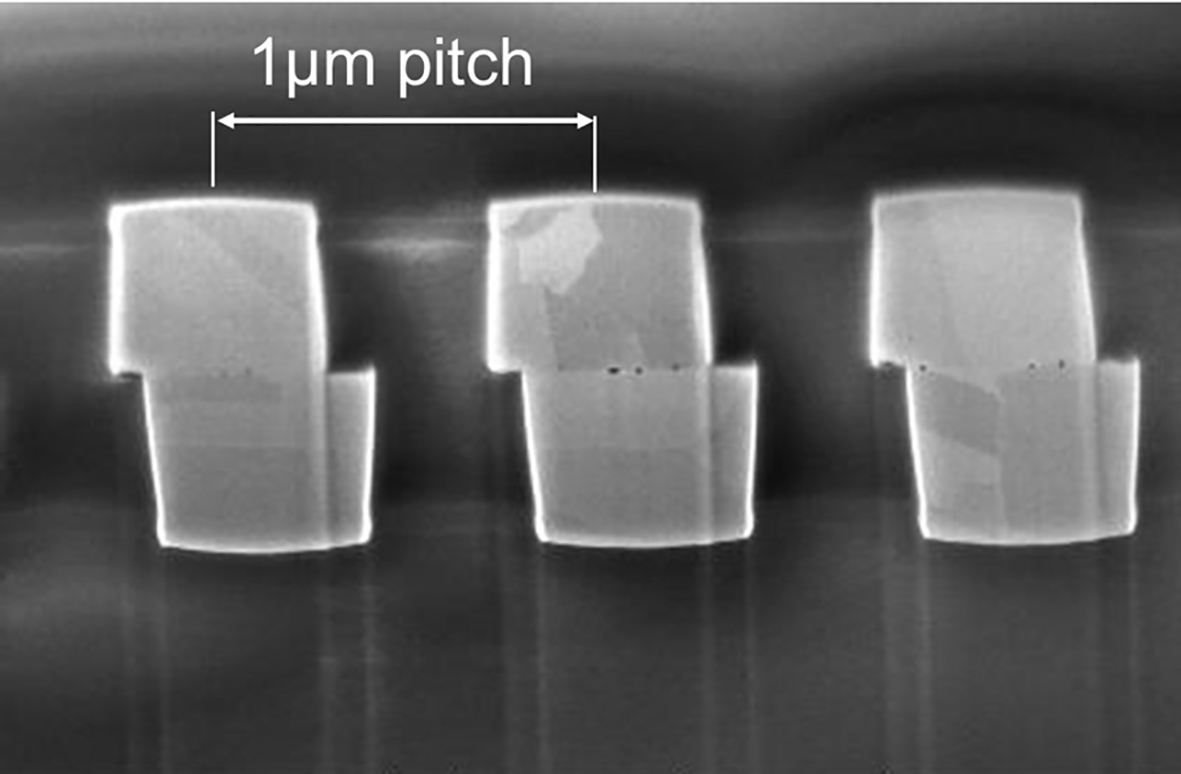
Querschnitt, aufgenommen mit einem Focused Ion Beam Scanning Electron Microscope (FIB-SEM): Kupfer-Kontakte mit 1um Pitch auf einem 300 mm-Waferpaar, gebondet mit dem EVG GEMINI®FB XT Automated Production Fusion Bonding System. Bildquelle: Leti.

GEMINI®FB XT Automated Production Fusion Bonding System.
ST. FLORIAN, Austria und GRENOBLE, Frankreich, 13. November 2017 – EV Group (EVG), ein führender Entwickler und Hersteller von Anlagen für Waferbonding- und Lithographieanwendungen in der Halbleiterindustrie, Mikrosystemtechnik und Nanotechnologie, und Leti, ein Institut von CEA Tech, verkündeten heute das weltweit erste, erfolgreiche 300 mm Wafer-to-Wafer Direct Hybrid Bonding mit elektrischen Kontakten im Abstand von nur einem Mikrometer. Bei diesem Durchbruch wurden zudem Kupfer-Kontaktpads von nur 500 nm Durchmesser erreicht..
Das Kupfer/Oxid-Hybridbonden, das einen zentralen Prozess zur Realisierung von 3D-IC Anwendungen mit hoher Packungsdichte darstellt, wurde in den Reinräumen von Leti mit einem vollautomatischen GEMINI® FB XT Fusions-Waferbonder von EVG demonstriert. Dieser Meilenstein wurde im Rahmen des IRT Nanoelec Programms, das von CEA angeführt wird, erreicht. EVG wurde im Februar 2016 Mitglied des 3D Integration Consortiums von IRT Nanoelec.
Wafer Bonding - ein grundlegender Prozess für das 3D Device Stacking
Das vertikale Stapeln von Halbleiterbausteinen hat sich zu einem immer erfolgsversprechenderen Ansatz entwickelt, um weitere Steigerungen bei der Packungsdichte und Leistung zu ermöglichen. Das Wafer-to-Wafer Bonden ist dabei ein essenzieller Prozessschritt, um dreidimendional gestapelte Devices herzustellen. Dabei wird jedoch eine hohe Alignment- und Overlay-Präzision zwischen den Wafern benötigt, um einen guten elektrischen Kontakt innerhalb der miteinander verbundenen Devices auf den gebondeten Wafern zu erreichen. Gleichzeitig soll die Kontaktfläche in der Bondschnittstelle minimiert werden, um auf dem Wafer mehr Platz für die Herstellung der eigentlichen Devices zu schaffen. Die kontinuierliche Reduzierung der Pitch-Werte, die zur Unterstützung der Roadmaps erforderlich sind, führt mit jeder neuen Produktgeneration zu immer stringenteren Wafer-to-Wafer Bond-Spezifikationen.
Ergebnisse der Machbarkeitsstudie
In der Demonstration von Leti wurden die oberen und unteren 300 mm Wafer auf dem automatischen GEMINI FB XT Produktionsbonder direkt gebondet. In diesem System ist EVGs proprietärer SmartView®NT Face-to-Face Aligner und ein Alignment Verification Modul integriert, das direkt im System Infrarot Alignment-Messungen nach dem Bondschritt erlaubt. Das System erreichte generell eine Overlay-Alignmentgenauigkeit von unter 195 nm (3 Sigma), wobei die mittleren Alignment-Werte im Bereich sogar unter 15 nm lagen. Post-Bake Acoustic Microscopy Scans des gesamten, gebondeten 300 mm Waferstapels sowie einzelner Dies bestätigten die Defekt-Freiheit des Bond-Interfaces mit optimaler Kupferdichte bei Pitches zwischen 1 und 4 µm.
"Unseres Wissens nach wurden bis heute keine Ergebnisse präsentiert, die die Machbarkeit von Kupfer-Hybridbonds mit Pitch-Werten unter 1.5 µm zeigen. Die aktuelle Demonstration stellt einen echten Durchbruch und einen wichtigen Schritt dar, um 3D Chip Stacking mit hoher Packungsdichte zu ermöglichen und am Ende auch kommerziell zu nutzen," sagte Frank Fournel, Head of Bonding Process Engineering bei CEA Leti.
Die Ergebnisse wurden in einem Paper mit dem Titel "1 µm Pitch Direct Hybrid Bonding with <300nm Wafer-to-wafer Overlay Accuracy," zusammengefasst, bei dem CEA Leti als Mitautor fungierte und das auf der IEEE S3S Conference 2017 präsentiert wurde.
"Die 3D Integration verspricht höhere Packungsdichten und Bandbreiten sowie einen niedrigeren Stromverbrauch in einer Vielzahl von Anwendungen, von CMOS Bildsensoren und MEMS-Bauteilen der nächsten Generation bis hin zur Hochleistungs-Datenverarbeitung," erklärte Markus Wimplinger, Corporate Technology Development and IP Director bei EV Group. "Als ein führendes Forschungs- und Entwicklungsinstitut im Bereich der 3D-Integration war Leti an vorderster Front daran beteiligt, diese wichtige Technologie zur industriellen Anwendung und Kommerzialisierung zu führen. EVG teilt diese Vision und wir freuen uns, dass wir Leti bei der Erreichung dieses Meilensteines in der 3D-Integration unterstützen konnten."
Basierend auf EVGs XT Frame Plattform und einem Equipment Front-End Modul (EFEM) ist der automatische Produktions-Fusionsbonder GEMINI FB XT für höchste Durchsatz- und Produktivitätswerte optimiert. Der in das System integrierte SmartView NT Aligner erreicht die industrieweit führende Wafer-to-Wafer Overlay Alignmentgenauigkeit von von unter 200 nm (3 Sigma). Darüber hinaus kann das System bis zu 6 Module für vor- und nachgelagerte Prozesse wie der Oberflächenvorbereitung und Konditionierung sowie Metrologie aufnehmen. Dazu zählen Waferreinigung, Plasma-Aktivierung, Alignment-Verifizierung, Debonden (um vor-gebondete Wafer bei Bedarf automatisch wieder trennen und neu prozessieren zu können) sowie Thermo-Kompressionsbonden.
EVG wird den GEMINI FB XT auf der SEMICON Europa, die vom 14. - 17. November in München stattfindet, präsentieren. Die Messebesucher können auf dem EVG-Stand Nr. B1-1424 mehr über dieses Produkt sowie über EVGs umfassendes Programm von Bonding- und Lithographielösungen erfahren.
Nähere Informationen zum EVG GEMINI FB XT automated production fusion bonding system finden Sie hier.
About Leti (France)
Leti, a technology research institute at CEA Tech, is a global leader in miniaturization technologies enabling smart, energy-efficient and secure solutions for industry. Founded in 1967, Leti pioneers micro-& nanotechnologies, tailoring differentiating applicative solutions for global companies, SMEs and startups. Leti tackles critical challenges in healthcare, energy and digital migration. From sensors to data processing and computing solutions, Leti's multidisciplinary teams deliver solid expertise, leveraging world-class pre-industrialization facilities. With a staff of more than 1,900, a portfolio of 2,700 patents, 91,500 sq. ft. of cleanroom space and a clear IP policy, the institute is based in Grenoble, France, and has offices in Silicon Valley and Tokyo. Leti has launched 60 startups and is a member of the Carnot Institutes network. This year, the institute celebrates its 50th anniversary.
Follow us on www.leti-cea.com and @CEA_Leti.
CEA Tech is the technology research branch of the French Alternative Energies and Atomic Energy Commission (CEA), a key player in innovative R&D, defence & security, nuclear energy, technological research for industry and fundamental science, identified by Thomson Reuters as the second most innovative research organization in the world. CEA Tech leverages a unique innovation-driven culture and unrivalled expertise to develop and disseminate new technologies for industry, helping to create high-end products and provide a competitive edge.
About EV Group (EVG)
EV Group (EVG) is a leading supplier of equipment and process solutions for the manufacture of semiconductors, microelectromechanical systems (MEMS), compound semiconductors, power devices and nanotechnology devices. Key products include wafer bonding, thin-wafer processing, lithography/nanoimprint lithography (NIL) and metrology equipment, as well as photoresist coaters, cleaners and inspection systems. Founded in 1980, EV Group services and supports an elaborate network of global customers and partners all over the world. More information about EVG is available at www.EVGroup.com.
About Nanoelec Research Technological Institute (IRT)
Nanoelec Research Technological Institute (IRT), headed by CEA-Leti conducts research and development in the field of information and communication technologies (ICT) and, specifically, micro- and nanoelectronics. Based in Grenoble, France, IRT Nanoelec leverages the area's proven innovation ecosystem to create the technologies that will power the nanoelectronics of tomorrow, drive new product development and inspire new applications - like the Internet of Things - for existing technologies. The R&D conducted at IRT Nanoelec provides early insight into how emerging technologies such as 3D integration and silicon photonics will affect integrated circuits. Visit www.irtnanoelec.fr.
IRT Nanoelec benefits from French State aid under the "Programme Investissements d'Avenir" bearing reference ANR-10-AIRT-05.
Leti Press Contact:
Agency
Tel: +33 6 74 93 23 47
E-mail: sldampoux@mahoneylyle.com
EV Group Contacts:
Clemens Schütte
Director, Marketing and Communications
EV Group
Tel: +43 7712 5311 0
E-mail: Marketing@EVGroup.com
David Moreno
Chief Marketing Officer
MCA, Inc.
Tel: +1.650.968.8900, ext. 125
E-mail: dmoreno@mcapr.com
IRT Nanoelec Contact:
Didier Louis
Tel: +33 438783653
E-mail: didier.louis@cea.fr
Download PDF