EN
English (EN)
Menu
- Products
- Technologies
- IR LayerRelease™ Technology
- MLE™ - Maskless Exposure Technology
- Nanoimprint Lithography (NIL) - SmartNIL®
- Wafer Level Optics
- Optical Lithography
- Resist Processing Technology
- Temporary Bonding and Debonding
- Eutectic Bonding
- Transient Liquid Phase (TLP) Bonding
- Anodic Bonding
- Metal Diffusion Bonding
- Fusion and Hybrid Bonding
- Die-to-Wafer Fusion and Hybrid Bonding
- ComBond® Technology
- Metrology
- Company
- Careers
Search
EVG®850 DB
Automated Debonding System
Fully automated debonding, cleaning and unloading of thin wafers
Within the fully automated debonder, the processed temporary bonding wafer stack is separated and cleaned, with the fragile device wafer always supported throughout the whole tool. Supported debonding methods include UV laser, thermal and mechanical debonding. With all debonding methods, the device wafer is either supported through film frame mounting or through a thin wafer handler.
Features
- Reliable handling of thinned, bowed and warped wafers with and without topography
- Automated cleaning of debonded wafer
- Recipe controlled system
- Real time monitoring and recording of all relevant process parameters
- Fully integrated SECS/GEM interface in automated tools
- Bridge tool capability for different substrate sizes
- Modular tool layout → throughput-optimized depending on specific process
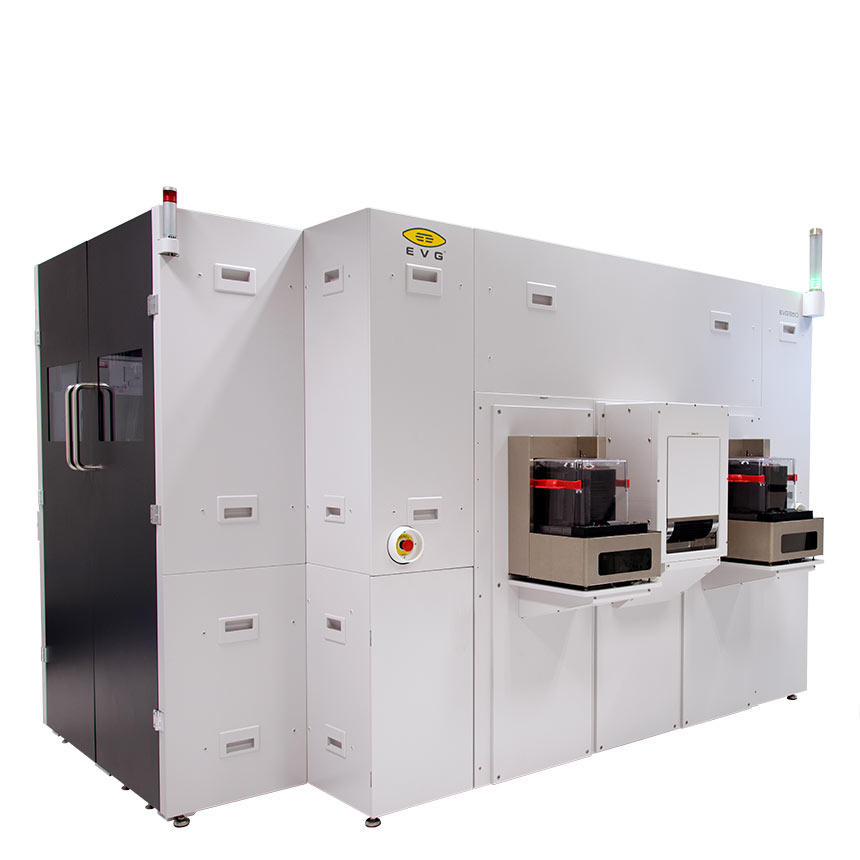
Technical Data
| Wafer diameter (substrate size) |
|---|
| Up to 300 mm |
| Up to 12“ film frame |
| Configuration |
|---|
| Debond module |
| Clean module |
| Film frame mounter |
| Options |
|---|
| ID reading |
| Various output formats |
| High topography wafer handling |
| Warped wafer handling |

Talk to our EVG product experts!
Questions?
Related technologies
Questions about our products and technologies?
Contact the EVG experts
Related News
NEW COOPERATIVE PROJECT MUSIC: COMPETITIVE SOLUTIONS FOR MICROACOUSTIC DEVICES
Apr, 2024
Protec MEMS Technology Orders Maskless Lithography System from EV Group for Advanced Memory Wafer Probe Card Manufacturing
Jan, 2024
EV Group Brings Revolutionary Layer Transfer Technology to High-Volume Manufacturing with EVG®850 NanoCleave™ System
Dec, 2023